
El transistor de efecto de campo ( FET ) es un tipo de transistor que utiliza un campo eléctrico para controlar el flujo de corriente en un semiconductor . Viene en dos tipos: FET de unión (JFET) y FET de semiconductor de óxido metálico (MOSFET). Los FET tienen tres terminales: fuente , compuerta y drenaje . Los FET controlan el flujo de corriente mediante la aplicación de un voltaje a la compuerta, que a su vez altera la conductividad entre el drenaje y la fuente.
Los FET también se conocen como transistores unipolares, ya que implican un funcionamiento de tipo portador único. Es decir, los FET utilizan electrones (canal n) o huecos (canal p) como portadores de carga en su funcionamiento, pero no ambos. Existen muchos tipos diferentes de transistores de efecto de campo. Los transistores de efecto de campo generalmente muestran una impedancia de entrada muy alta a bajas frecuencias. El transistor de efecto de campo más utilizado es el MOSFET (transistor de efecto de campo de metal-óxido-semiconductor).
.jpg/440px-Julius_Edgar_Lilienfeld_(1881-1963).jpg)
El concepto de transistor de efecto de campo (FET) fue patentado por primera vez por el físico austrohúngaro Julius Edgar Lilienfeld en 1925 [1] y por Oskar Heil en 1934, pero no pudieron construir un dispositivo semiconductor práctico y funcional basado en el concepto. El efecto transistor fue observado y explicado más tarde por John Bardeen y Walter Houser Brattain mientras trabajaban con William Shockley en Bell Labs en 1947, poco después de que expirara la patente de 17 años. Shockley inicialmente intentó construir un FET funcional tratando de modular la conductividad de un semiconductor , pero no tuvo éxito, principalmente debido a problemas con los estados de superficie , el enlace colgante y los materiales compuestos de germanio y cobre . En el curso de sus intentos por comprender las misteriosas razones detrás de su fracaso en construir un FET funcional, Bardeen y Brattain inventaron el transistor de contacto puntual en 1947, al que siguió el transistor de unión bipolar de Shockley en 1948. [2] [3]
El primer dispositivo FET que se construyó con éxito fue el transistor de efecto de campo de unión (JFET). [2] Un JFET fue patentado por primera vez por Heinrich Welker en 1945. [4] El transistor de inducción estática (SIT), un tipo de JFET con un canal corto, fue inventado por los ingenieros japoneses Jun-ichi Nishizawa e Y. Watanabe en 1950. Después del tratamiento teórico de Shockley sobre el JFET en 1952, George C. Dacey e Ian M. Ross construyeron un JFET práctico en 1953. [5] Sin embargo, el JFET todavía tenía problemas que afectaban a los transistores de unión en general. [6] Los transistores de unión eran dispositivos relativamente voluminosos que eran difíciles de fabricar en una base de producción en masa , lo que los limitaba a una serie de aplicaciones especializadas. El transistor de efecto de campo de puerta aislada (IGFET) fue teorizado como una alternativa potencial a los transistores de unión, pero los investigadores no pudieron construir IGFET funcionales, en gran medida debido a la problemática barrera de estado de superficie que impedía que el campo eléctrico externo penetrara en el material. [6] A mediados de la década de 1950, los investigadores habían abandonado en gran medida el concepto de FET y, en su lugar, se centraron en la tecnología de transistores de unión bipolar (BJT). [7]
Los fundamentos de la tecnología MOSFET fueron establecidos por el trabajo de William Shockley , John Bardeen y Walter Brattain . Shockley imaginó de forma independiente el concepto de FET en 1945, pero no pudo construir un dispositivo que funcionara. Al año siguiente, Bardeen explicó su fracaso en términos de estados de superficie . Bardeen aplicó la teoría de estados de superficie a semiconductores (trabajos previos sobre estados de superficie fueron realizados por Shockley en 1939 e Igor Tamm en 1932) y se dio cuenta de que el campo externo estaba bloqueado en la superficie debido a electrones adicionales que son atraídos a la superficie del semiconductor. Los electrones quedan atrapados en esos estados localizados formando una capa de inversión. La hipótesis de Bardeen marcó el nacimiento de la física de superficies . Bardeen decidió entonces hacer uso de una capa de inversión en lugar de la capa muy fina de semiconductor que Shockley había previsto en sus diseños de FET. Basándose en su teoría, en 1948 Bardeen patentó el progenitor del MOSFET, un transistor de efecto de campo de compuerta aislada (IGFET) con una capa de inversión. La capa de inversión limita el flujo de portadores minoritarios, aumentando la modulación y la conductividad, aunque su transporte de electrones depende del aislante de la compuerta o de la calidad del óxido, si se utiliza como aislante, depositado sobre la capa de inversión. La patente de Bardeen, así como el concepto de capa de inversión, forman la base de la tecnología CMOS actual. En 1976, Shockley describió la hipótesis del estado superficial de Bardeen como "una de las ideas de investigación más significativas en el programa de semiconductores". [8]
Después de la teoría de los estados superficiales de Bardeen, el trío intentó superar el efecto de los estados superficiales. A finales de 1947, Robert Gibney y Brattain sugirieron el uso de un electrolito colocado entre el metal y el semiconductor para superar los efectos de los estados superficiales. Su dispositivo FET funcionó, pero la amplificación fue deficiente. Bardeen fue más allá y sugirió centrarse en la conductividad de la capa de inversión. Experimentos posteriores los llevaron a reemplazar el electrolito con una capa de óxido sólido con la esperanza de obtener mejores resultados. Su objetivo era penetrar la capa de óxido y llegar a la capa de inversión. Sin embargo, Bardeen sugirió que cambiaran de silicio a germanio y en el proceso su óxido se eliminó inadvertidamente. Se toparon con un transistor completamente diferente, el transistor de contacto puntual . Lillian Hoddeson sostiene que "si Brattain y Bardeen hubieran estado trabajando con silicio en lugar de germanio, se habrían topado con un transistor de efecto de campo exitoso". [8] [9] [10] [11] [12]
A finales de la primera mitad de la década de 1950, tras el trabajo teórico y experimental de Bardeen, Brattain, Kingston, Morrison y otros, se hizo más claro que había dos tipos de estados superficiales. Se descubrió que los estados superficiales rápidos estaban asociados con la masa y una interfaz semiconductor/óxido. Se descubrió que los estados superficiales lentos estaban asociados con la capa de óxido debido a la adsorción de átomos, moléculas e iones por el óxido del ambiente. Se descubrió que estos últimos eran mucho más numerosos y tenían tiempos de relajación mucho más largos . En ese momento, Philo Farnsworth y otros idearon varios métodos para producir superficies semiconductoras atómicamente limpias.
En 1955, Carl Frosch y Lincoln Derrick cubrieron accidentalmente la superficie de una oblea de silicio con una capa de dióxido de silicio . [13] Demostraron que la capa de óxido impedía que ciertos dopantes entraran en la oblea de silicio, mientras que permitía que entraran otros, descubriendo así el efecto pasivador de la oxidación en la superficie del semiconductor. Su trabajo posterior demostró cómo grabar pequeñas aberturas en la capa de óxido para difundir dopantes en áreas seleccionadas de la oblea de silicio. En 1957, publicaron un artículo de investigación y patentaron su técnica resumiendo su trabajo. La técnica que desarrollaron se conoce como enmascaramiento de difusión de óxido, que más tarde se utilizaría en la fabricación de dispositivos MOSFET. [14] En Bell Labs, la importancia de la técnica de Frosch se comprendió de inmediato. Los resultados de su trabajo circularon por Bell Labs en forma de memorandos BTL antes de ser publicados en 1957. En Shockley Semiconductor , Shockley había hecho circular la preimpresión de su artículo en diciembre de 1956 a todo su personal superior, incluido Jean Hoerni . [6] [15] [16]
En 1955, Ian Munro Ross presentó una patente para un FeFET o MFSFET. Su estructura era como la de un MOSFET de canal de inversión moderno, pero se utilizó material ferroeléctrico como dieléctrico/aislante en lugar de óxido. Lo imaginó como una forma de memoria, años antes del MOSFET de puerta flotante . En febrero de 1957, John Wallmark presentó una patente para FET en el que se utilizó monóxido de germanio como dieléctrico de puerta, pero no persiguió la idea. En su otra patente presentada el mismo año describió un FET de doble puerta . En marzo de 1957, en su cuaderno de laboratorio, Ernesto Labate, un científico investigador de Bell Labs , concibió un dispositivo similar al MOSFET propuesto posteriormente, aunque el dispositivo de Labate no utilizó explícitamente dióxido de silicio como aislante. [17] [18] [19] [20]

En 1955, Carl Frosch y Lincoln Derrick accidentalmente hicieron crecer una capa de dióxido de silicio sobre la oblea de silicio, para lo cual observaron efectos de pasivación superficial . [21] [22] En 1957, Frosch y Derrick, utilizando enmascaramiento y predeposición, pudieron fabricar transistores de dióxido de silicio y demostraron que el dióxido de silicio aislaba, protegía las obleas de silicio y evitaba que los dopantes se difundieran en la oblea. [21] [23] JR Ligenza y WG Spitzer estudiaron el mecanismo de los óxidos cultivados térmicamente y fabricaron una pila de Si/ SiO2 de alta calidad en 1960. [24] [25] [26]
Después de esta investigación, Mohamed Atalla y Dawon Kahng propusieron un transistor MOS de silicio en 1959 [27] y demostraron con éxito un dispositivo MOS funcional con su equipo de Bell Labs en 1960. [28] [29] Su equipo incluía a EE LaBate y EI Povilonis, quienes fabricaron el dispositivo; MO Thurston, LA D'Asaro y JR Ligenza, quienes desarrollaron los procesos de difusión, y HK Gummel y R. Lindner, quienes caracterizaron el dispositivo. [30] [31]
Con su alta escalabilidad , [32] y un consumo de energía mucho menor y una mayor densidad que los transistores de unión bipolar, [33] el MOSFET hizo posible construir circuitos integrados de alta densidad . [34] El MOSFET también es capaz de manejar mayor potencia que el JFET. [35] El MOSFET fue el primer transistor verdaderamente compacto que podía miniaturizarse y producirse en masa para una amplia gama de usos. [6] El MOSFET se convirtió así en el tipo de transistor más común en computadoras, electrónica, [36] y tecnología de comunicaciones (como los teléfonos inteligentes ). [37] La Oficina de Patentes y Marcas de los Estados Unidos lo llama una "invención innovadora que transformó la vida y la cultura en todo el mundo". [37]
El CMOS (MOS complementario), un proceso de fabricación de dispositivos semiconductores para MOSFET, fue desarrollado por Chih-Tang Sah y Frank Wanlass en Fairchild Semiconductor en 1963. [38] [39] El primer informe de un MOSFET de compuerta flotante fue realizado por Dawon Kahng y Simon Sze en 1967. [40] Un MOSFET de doble compuerta fue demostrado por primera vez en 1984 por los investigadores del Laboratorio Electrotécnico Toshihiro Sekigawa y Yutaka Hayashi. [41] [42] El FinFET (transistor de efecto de campo de aletas), un tipo de MOSFET multipuerta no planar 3D , se originó a partir de la investigación de Digh Hisamoto y su equipo en el Laboratorio Central de Investigación de Hitachi en 1989. [43] [44]
Los FET pueden ser dispositivos con portadores de carga mayoritarios, en los que la corriente es transportada predominantemente por portadores mayoritarios, o dispositivos con portadores de carga minoritarios, en los que la corriente se debe principalmente a un flujo de portadores minoritarios. [45] El dispositivo consta de un canal activo a través del cual fluyen portadores de carga, electrones o huecos , desde la fuente hasta el drenador. Los conductores terminales de fuente y drenador están conectados al semiconductor a través de contactos óhmicos . La conductividad del canal es una función del potencial aplicado a través de los terminales de compuerta y fuente.
Los tres terminales del FET son: [46]
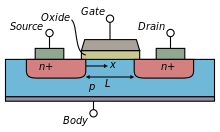
Todos los FET tienen terminales de fuente , drenaje y compuerta que corresponden aproximadamente al emisor , colector y base de los BJT . La mayoría de los FET tienen un cuarto terminal llamado cuerpo , base , masa o sustrato . Este cuarto terminal sirve para polarizar el transistor para que funcione; es raro hacer un uso no trivial del terminal del cuerpo en los diseños de circuitos, pero su presencia es importante al configurar el diseño físico de un circuito integrado . El tamaño de la compuerta, longitud L en el diagrama, es la distancia entre la fuente y el drenaje. El ancho es la extensión del transistor, en la dirección perpendicular a la sección transversal en el diagrama (es decir, dentro/fuera de la pantalla). Normalmente, el ancho es mucho mayor que la longitud de la compuerta. Una longitud de compuerta de 1 μm limita la frecuencia superior a aproximadamente 5 GHz, 0,2 μm a aproximadamente 30 GHz.
Los nombres de los terminales hacen referencia a sus funciones. Se puede pensar que el terminal de compuerta controla la apertura y el cierre de una compuerta física. Esta compuerta permite que los electrones fluyan a través de ella o bloquea su paso creando o eliminando un canal entre la fuente y el drenador. El flujo de electrones desde el terminal de fuente hacia el terminal de drenador se ve influenciado por un voltaje aplicado. El cuerpo simplemente se refiere a la masa del semiconductor en la que se encuentran la compuerta, la fuente y el drenador. Por lo general, el terminal del cuerpo está conectado al voltaje más alto o más bajo dentro del circuito, según el tipo de FET. El terminal del cuerpo y el terminal de fuente a veces están conectados entre sí, ya que la fuente a menudo está conectada al voltaje más alto o más bajo dentro del circuito, aunque hay varios usos de los FET que no tienen dicha configuración, como las compuertas de transmisión y los circuitos en cascada .
A diferencia de los BJT, la gran mayoría de los FET son eléctricamente simétricos. Por lo tanto, los terminales de fuente y drenaje se pueden intercambiar en circuitos prácticos sin cambiar las características de funcionamiento ni la función. Esto puede resultar confuso cuando los FET parecen estar conectados "al revés" en los diagramas esquemáticos y circuitos porque la orientación física del FET se decidió por otras razones, como consideraciones de diseño del circuito impreso.



El FET controla el flujo de electrones (o huecos de electrones ) desde la fuente hasta el drenaje al afectar el tamaño y la forma de un "canal conductor" creado e influenciado por el voltaje (o la falta de voltaje) aplicado a través de las terminales de la compuerta y la fuente. (Para simplificar, esta discusión supone que el cuerpo y la fuente están conectados). Este canal conductor es la "corriente" a través de la cual fluyen los electrones desde la fuente hasta el drenaje.
En un dispositivo de "modo de agotamiento" de canal n , un voltaje negativo de compuerta a fuente hace que una región de agotamiento se expanda en anchura e invada el canal desde los lados, estrechándolo. Si la región activa se expande para cerrar completamente el canal, la resistencia del canal desde la fuente hasta el drenador aumenta y el FET se apaga efectivamente como un interruptor (ver figura de la derecha, cuando hay una corriente muy pequeña). Esto se llama "desconexión", y el voltaje en el que ocurre se llama "voltaje de conexión". Por el contrario, un voltaje positivo de compuerta a fuente aumenta el tamaño del canal y permite que los electrones fluyan fácilmente (ver figura de la derecha, cuando hay un canal de conducción y la corriente es grande).
En un dispositivo de "modo de mejora" de canal n, no existe un canal conductor de forma natural dentro del transistor, y se necesita un voltaje positivo de compuerta a fuente para crear uno. El voltaje positivo atrae a los electrones que flotan libremente dentro del cuerpo hacia la compuerta, formando un canal conductor. Pero primero, se deben atraer suficientes electrones cerca de la compuerta para contrarrestar los iones dopantes agregados al cuerpo del FET; esto forma una región sin portadores móviles llamada región de agotamiento , y el voltaje en el que esto ocurre se conoce como el voltaje umbral del FET. Un mayor aumento del voltaje de compuerta a fuente atraerá aún más electrones hacia la compuerta que pueden crear un canal activo desde la fuente hasta el drenador; este proceso se llama inversión .
En un dispositivo de "modo de agotamiento" de canal p , un voltaje positivo desde la compuerta al cuerpo ensancha la capa de agotamiento al forzar a los electrones a ir a la interfaz compuerta-aislante/semiconductor, dejando expuesta una región libre de portadores de iones aceptores inmóviles y cargados positivamente.
Por el contrario, en un dispositivo de "modo de mejora" de canal p, no existe una región conductora y se debe utilizar voltaje negativo para generar un canal de conducción.
Tanto en el caso de dispositivos en modo de mejora como en el de agotamiento, con voltajes de drenaje a fuente mucho menores que los voltajes de compuerta a fuente, al cambiar el voltaje de compuerta se alterará la resistencia del canal, y la corriente de drenaje será proporcional al voltaje de drenaje (referenciado al voltaje de fuente). En este modo, el FET funciona como una resistencia variable y se dice que el FET está funcionando en un modo lineal o en un modo óhmico. [47] [48]
Si se aumenta el voltaje de drenaje a fuente, esto crea un cambio asimétrico significativo en la forma del canal debido a un gradiente de potencial de voltaje de fuente a drenaje. La forma de la región de inversión se "estrecha" cerca del extremo de drenaje del canal. Si se aumenta aún más el voltaje de drenaje a fuente, el punto de estrangulamiento del canal comienza a alejarse del drenaje hacia la fuente. Se dice que el FET está en modo de saturación ; [49] aunque algunos autores se refieren a él como modo activo , para una mejor analogía con las regiones operativas de transistores bipolares. [50] [51]El modo de saturación, o la región entre el modo óhmico y el modo de saturación, se utiliza cuando se necesita amplificación. La región intermedia a veces se considera parte de la región óhmica o lineal, incluso cuando la corriente de drenaje no es aproximadamente lineal con el voltaje de drenaje.
Aunque el canal conductor formado por el voltaje de compuerta a fuente ya no conecta la fuente con el drenador durante el modo de saturación, los portadores no tienen bloqueado el flujo. Considerando nuevamente un dispositivo de modo de mejora de canal n, existe una región de agotamiento en el cuerpo de tipo p, que rodea el canal conductor y las regiones de drenador y fuente. Los electrones que componen el canal son libres de moverse fuera del canal a través de la región de agotamiento si son atraídos al drenador por el voltaje de drenador a fuente. La región de agotamiento está libre de portadores y tiene una resistencia similar al silicio . Cualquier aumento del voltaje de drenador a fuente aumentará la distancia desde el drenador hasta el punto de estrangulamiento, aumentando la resistencia de la región de agotamiento en proporción al voltaje de drenador a fuente aplicado. Este cambio proporcional hace que la corriente de drenador a fuente permanezca relativamente fija, independientemente de los cambios en el voltaje de drenador a fuente, muy a diferencia de su comportamiento óhmico en el modo de operación lineal. Por lo tanto, en el modo de saturación, el FET se comporta como una fuente de corriente constante en lugar de como una resistencia, y puede utilizarse eficazmente como un amplificador de tensión. En este caso, la tensión de compuerta a fuente determina el nivel de corriente constante a través del canal.
Los FET se pueden construir a partir de varios semiconductores, de los cuales el silicio es, con diferencia, el más común. La mayoría de los FET se fabrican utilizando técnicas convencionales de procesamiento de semiconductores en masa , utilizando una oblea semiconductora monocristalina como región activa o canal.
Entre los materiales de cuerpo más inusuales se encuentran el silicio amorfo , el silicio policristalino u otros semiconductores amorfos en transistores de película delgada o transistores de efecto de campo orgánicos (OFET) que se basan en semiconductores orgánicos ; a menudo, los aisladores de compuerta y los electrodos de OFET también están hechos de materiales orgánicos. Estos FET se fabrican utilizando una variedad de materiales como carburo de silicio (SiC), arseniuro de galio (GaAs), nitruro de galio (GaN) y arseniuro de indio y galio (InGaAs).
En junio de 2011, IBM anunció que había utilizado con éxito FET basados en grafeno en un circuito integrado . [52] [53] Estos transistores son capaces de alcanzar una frecuencia de corte de aproximadamente 2,23 GHz, mucho más alta que los FET de silicio estándar. [54]

El canal de un FET se dopa para producir un semiconductor de tipo n o un semiconductor de tipo p. El drenador y la fuente pueden estar dopados con un tipo opuesto al del canal, en el caso de los FET de modo de mejora, o con un tipo similar al del canal, como en el caso de los FET de modo de empobrecimiento. Los transistores de efecto de campo también se distinguen por el método de aislamiento entre el canal y la compuerta. Los tipos de FET incluyen:
Los transistores de efecto de campo tienen una alta resistencia de corriente de compuerta a drenaje, del orden de 100 MΩ o más, lo que proporciona un alto grado de aislamiento entre el control y el flujo. Debido a que el ruido de la corriente de base aumentará con el tiempo de modelado [ aclaración necesaria ] , [66] un FET normalmente produce menos ruido que un transistor de unión bipolar (BJT), y se encuentra en la electrónica sensible al ruido, como sintonizadores y amplificadores de bajo ruido para receptores de VHF y satélite. No exhibe voltaje de compensación en corriente de drenaje cero y es un excelente cortador de señal. Normalmente tiene una mejor estabilidad térmica que un BJT. [46]
Debido a que los FET están controlados por la carga de la compuerta, una vez que la compuerta está cerrada o abierta, no hay consumo de energía adicional, como sucedería con un transistor de unión bipolar o con relés sin enclavamiento en algunos estados. Esto permite una conmutación de potencia extremadamente baja, lo que a su vez permite una mayor miniaturización de los circuitos porque las necesidades de disipación de calor se reducen en comparación con otros tipos de interruptores.
Un transistor de efecto de campo tiene un producto de ganancia-ancho de banda relativamente bajo en comparación con un transistor de unión bipolar. Los MOSFET son muy susceptibles a voltajes de sobrecarga, por lo que requieren un manejo especial durante la instalación. [67] La frágil capa aislante del MOSFET entre la compuerta y el canal lo hace vulnerable a descargas electrostáticas o cambios en el voltaje umbral durante la manipulación. Esto no suele ser un problema después de que el dispositivo se haya instalado en un circuito correctamente diseñado.
Los FET suelen tener una resistencia de "encendido" muy baja y una resistencia de "apagado" alta. Sin embargo, las resistencias intermedias son significativas, por lo que los FET pueden disipar grandes cantidades de energía durante la conmutación. Por lo tanto, la eficiencia puede hacer que la conmutación sea más importante, pero esto puede causar transitorios que pueden excitar inductancias parásitas y generar voltajes significativos que pueden acoplarse a la compuerta y causar una conmutación involuntaria. Por lo tanto, los circuitos FET pueden requerir un diseño muy cuidadoso y pueden implicar compensaciones entre la velocidad de conmutación y la disipación de energía. También existe un equilibrio entre la clasificación de voltaje y la resistencia de "encendido", por lo que los FET de alto voltaje tienen una resistencia de "encendido" relativamente alta y, por lo tanto, pérdidas de conducción. [68]
Los transistores de efecto de campo son relativamente robustos, especialmente cuando funcionan dentro de las limitaciones eléctricas y de temperatura definidas por el fabricante ( reducción de potencia adecuada ). Sin embargo, los dispositivos FET modernos a menudo pueden incorporar un diodo de cuerpo . Si no se tienen en cuenta las características del diodo de cuerpo, el FET puede experimentar un comportamiento de diodo de cuerpo lento, donde un transistor parásito se encenderá y permitirá que se extraiga una corriente alta del drenaje a la fuente cuando el FET está apagado. [69]
El FET más utilizado es el MOSFET . La tecnología de proceso CMOS (semiconductor de óxido metálico complementario) es la base de los circuitos integrados digitales modernos . Esta tecnología de proceso utiliza una disposición en la que el MOSFET de canal p (normalmente "en modo de mejora") y el MOSFET de canal n están conectados en serie de modo que cuando uno está encendido, el otro está apagado.
En los FET, los electrones pueden fluir en cualquier dirección a través del canal cuando se opera en modo lineal. La convención de nombres de terminal de drenaje y terminal de fuente es algo arbitraria, ya que los dispositivos generalmente (pero no siempre) se construyen simétricos de fuente a drenaje. Esto hace que los FET sean adecuados para conmutar señales analógicas entre rutas ( multiplexación ). Con este concepto, se puede construir una mesa de mezclas de estado sólido , por ejemplo. El FET se usa comúnmente como amplificador. Por ejemplo, debido a su gran resistencia de entrada y baja resistencia de salida, es eficaz como búfer en la configuración de drenaje común (seguidor de fuente).
Los IGBT se utilizan para conmutar bobinas de encendido de motores de combustión interna, donde la conmutación rápida y las capacidades de bloqueo de voltaje son importantes.
Los transistores con compuerta de fuente son más resistentes a los problemas ambientales y de fabricación en dispositivos electrónicos de área grande, como pantallas de visualización, pero su funcionamiento es más lento que el de los FET. [70]