La creación de patrones múltiples (o multi-patterning ) es una clase de tecnologías para la fabricación de circuitos integrados (CI), desarrollada para la fotolitografía con el fin de mejorar la densidad de características. Se espera que sea necesaria para los procesos de semiconductores de nodos de 10 nm y 7 nm y más allá. La premisa es que una sola exposición litográfica puede no ser suficiente para proporcionar una resolución suficiente. Por lo tanto, se necesitarían exposiciones adicionales o, de lo contrario, sería necesario posicionar patrones utilizando paredes laterales de características grabadas (utilizando espaciadores).

Incluso con una única exposición con suficiente resolución, se han implementado máscaras adicionales para una mejor calidad de los patrones, como por ejemplo Intel para el corte de línea en su nodo de 45 nm [1] o TSMC en su nodo de 28 nm. [2] Incluso para la litografía por haz de electrones , la exposición única parece insuficiente a un paso medio de ~10 nm, por lo que se requiere un patrón doble. [3] [4]
La litografía de doble patrón fue demostrada por primera vez en 1983 por DC Flanders y NN Efremow. [5] Desde entonces, se han desarrollado varias técnicas de doble patrón, como el doble patrón de autoalineación (SADP) y un enfoque de solo litografía para el doble patrón. [6] [7]
Gurtej Singh Sandhu de Micron Technology fue pionero en el uso de patrones dobles de paso durante la década de 2000, lo que condujo al desarrollo de la memoria flash NAND de 30 nm . Desde entonces, los fabricantes de memorias flash NAND y de acceso aleatorio de todo el mundo han adoptado ampliamente el uso de patrones múltiples . [8] [9]
Hay una serie de situaciones que pueden dar lugar a que sea necesario crear múltiples patrones.

El caso más obvio que requiere patrones múltiples es cuando el paso de la característica está por debajo del límite de resolución del sistema de proyección óptica. Para un sistema con apertura numérica NA y longitud de onda λ, cualquier paso por debajo de 0,5 λ/NA no sería resoluble en una única exposición de oblea. El límite de resolución también puede originarse a partir de efectos estocásticos, como en el caso de EUV . En consecuencia, el ancho de línea de 20 nm aún requiere patrones dobles de EUV, debido a una mayor defectividad en pasos mayores. [10]

Está bien establecido que los patrones densos bidimensionales, que se forman a partir de la interferencia de dos o tres haces a lo largo de una dirección, como en la iluminación cuadrupolar o QUASAR, están sujetos a un redondeo significativo, particularmente en curvas y esquinas. [11] [12] [13] El radio de redondeo de las esquinas es mayor que el paso mínimo (~0,7 λ/NA). [14] Esto también contribuye a los puntos calientes para tamaños de características de ~0,4 λ/NA o menores. [15] Por esta razón, es ventajoso definir primero los patrones de línea y luego cortar segmentos de dichas líneas en consecuencia. [16] Por supuesto, esto requiere exposiciones adicionales. Las formas cortadas también pueden ser redondas, lo que requiere una precisión de colocación estricta. [16] [17] [18]
El redondeo de las puntas de las líneas conduce naturalmente a un equilibrio entre la reducción del ancho de la línea (es decir, el ancho de la punta de la línea) y la reducción del espacio entre las puntas enfrentadas opuestas. A medida que el ancho de la línea se reduce, el radio de la punta se reduce. Cuando la punta de la línea ya es menor que la función de dispersión de puntos (k 1 ~0,6–0,7), la punta de la línea se retrae naturalmente, [19] aumentando el espacio entre las puntas enfrentadas opuestas. La función de dispersión de puntos limita asimismo la distancia resoluble entre los centros de las puntas de las líneas (modeladas como círculos). Esto conduce a su vez a un equilibrio entre la reducción del ancho de la celda y la reducción de la altura de la celda. El equilibrio se evita añadiendo una máscara de corte/recorte (véase la discusión a continuación). [20] Por lo tanto, para el nodo de 7 nm dirigido a EUV, con un ancho de línea de metal de 18 nm (k 1 = 0,44 para λ = 13,5 nm, NA = 0,33), la brecha de la punta de la línea de menos de 25 nm (k 1 = 0,61) implica que el patrón único EUV no es suficiente; es necesaria una segunda exposición de corte.

Cuando los patrones incluyen tamaños de características cercanos al límite de resolución, es común que diferentes disposiciones de dichas características requieran iluminaciones específicas para su impresión. [21]
El ejemplo más básico es el de líneas densas horizontales frente a líneas verticales (paso medio < 0,35 λ/NA), donde las primeras requieren una iluminación dipolar Norte-Sur mientras que las segundas requieren una iluminación dipolar Este-Oeste. Si se utilizan ambos tipos (también conocido como C-Quad de cuadrupolo cruzado), el dipolo inadecuado degrada la imagen de la orientación de línea respectiva. [22] Pasos mayores de hasta λ/NA pueden tener líneas horizontales y verticales acomodadas por iluminación cuadrupolo o QUASAR, pero las características espaciadas en diagonal y las características de codo se degradan. [23] [24]
En DRAM , la matriz y la periferia están expuestas a diferentes condiciones de iluminación . Por ejemplo, la matriz podría estar expuesta con iluminación dipolar mientras que la periferia podría usar iluminación anular. [25] Esta situación se aplica a cualquier conjunto de patrones (paso medio < 0,5 λ/NA) con diferentes pasos o diferentes disposiciones de características, por ejemplo, matrices rectangulares frente a matrices escalonadas. [26] [27] [28] [29] Cualquiera de los patrones individuales se puede resolver, pero no se puede utilizar una única iluminación simultáneamente para todos ellos. Un paso mínimo puede requerir una iluminación que sea perjudicial para el doble del paso mínimo con desenfoque. [30] [31]
La inclusión de características tanto aisladas como densas es un ejemplo bien conocido de creación de patrones de múltiples tonos. Las características de asistencia de subresolución (SRAF) se han diseñado para permitir la creación de patrones de características aisladas cuando se utiliza iluminación adaptada a las características densas. Sin embargo, no se pueden cubrir todos los rangos de tonos. En particular, las características semidensas pueden no ser fáciles de incluir. [32] [33]

En el caso específico de los conjuntos de agujeros (paso mínimo < 0,6 λ/NA), existen tres casos bien conocidos que requieren tres iluminaciones completamente diferentes. Un conjunto regular generalmente requiere iluminación Quasar, mientras que el mismo conjunto rotado 45 grados da como resultado un conjunto de tablero de ajedrez que requiere iluminación C-quad. [29] A diferencia de ambos casos, un conjunto con simetría cercana a la triangular o hexagonal requiere iluminación hexapolar. [34]


A veces, un patrón de características contiene inherentemente más de un tono y, además, estos tonos son incompatibles hasta el punto de que ninguna iluminación puede generar imágenes simultáneas de ambos tonos de manera satisfactoria. Un ejemplo común, nuevamente de DRAM, es el patrón de ladrillo que define las regiones activas de la matriz. [35] [36] Además del tono estrecho de las regiones activas, también existe el tono entre las separaciones o cortes de las regiones activas, que es diferente del tono estrecho en la misma dirección. Cuando el tono estrecho es < λ/NA (pero aún > 0,5 λ/NA), no se puede generar imágenes simultáneamente con el tono doble debido a las limitaciones de enfoque de este último. El grabado selectivo, junto con SADP o SAQP (que se describirán a continuación), es el mejor enfoque actual para lograr la generación simultánea de patrones de ambos tonos. [37]
Un patrón de interferencia de dos haces (paso medio <0,5 λ/NA) forma un conjunto de líneas espaciadas regularmente. Las rupturas en dichas líneas, por ejemplo, patrones de ladrillos, son desviaciones del patrón de interferencia. Dichas rupturas generalmente no dominan el patrón y, por lo tanto, son pequeñas desviaciones. Estas desviaciones son insuficientes para compensar por completo la interferencia constructiva o destructiva del patrón de línea regular subyacente; a menudo resultan lóbulos laterales. [38] [39] Los espacios en los extremos de las líneas se pueden salvar fácilmente bajo la iluminación dipolar. [40] Por lo tanto, es necesaria otra exposición de máscara (generalmente denominada máscara de corte) para romper el patrón de línea de manera más robusta.

La primera implementación de patrones múltiples implicó el corte de líneas. Esto ocurrió por primera vez para el nodo de 45 nm de Intel, para un paso de compuerta de 160 nm. [41] El uso de una segunda máscara para cortar líneas definidas por una primera máscara no ayuda a aumentar la densidad de características directamente. En cambio, permite la definición de características, por ejemplo, patrones de ladrillos, que se basan en líneas espaciadas a un paso mínimo, en particular, cuando las líneas están cerca del límite de resolución y son generadas por la interferencia de dos haces mencionada anteriormente. La interferencia de dos haces aún domina el patrón de difracción. [38] De hecho, en ausencia de una exposición de corte separada, la brecha entre los extremos de las líneas de paso mínimo será prohibitivamente grande. [42] [43] Esto se debe al redondeo resultante de frecuencias espaciales reducidas. [44]
Las formas de corte de línea en sí mismas están sujetas a redondeo; este redondeo se puede minimizar con una iluminación optimizada, [45] pero no se puede eliminar por completo.
Al aplicar la segunda máscara a las líneas de corte, se debe tener en cuenta la superposición relativa a la primera máscara; de lo contrario, pueden producirse errores de colocación de bordes (EPE). Si el paso de línea ya está cerca del límite de resolución, el patrón de corte en sí puede presentar dificultades para obtener imágenes, debido a una dosis reducida o una ventana de enfoque. La variabilidad estocástica EUV provoca una forma aleatoria de los cortes. [46] En este caso, se tendría que utilizar más de una máscara de corte, o bien el corte tiene que extenderse sobre más de una línea. El corte de línea autoalineado (que se analizará más adelante) puede ser una opción preferida.



La primera forma de modelado múltiple implicaba simplemente dividir un patrón en dos o tres partes, cada una de las cuales puede procesarse de manera convencional, con el patrón completo combinado al final en la capa final. Esto a veces se llama división de paso , ya que no se pueden obtener imágenes de dos características separadas por un paso, por lo que solo se pueden obtener imágenes de las características omitidas a la vez. También se lo denomina de manera más directa como "LELE" (Litho-Etch-Litho-Etch). Este enfoque se ha utilizado para los nodos de 20 nm y 14 nm. Se toleró el costo adicional de las exposiciones adicionales ya que solo las necesitarían unas pocas capas críticas. Una preocupación más seria era el efecto de los errores de posicionamiento de característica a característica (superposición). En consecuencia, el enfoque de imágenes de pared lateral autoalineadas (descrito a continuación) ha sucedido a este enfoque.
Un método de "fuerza bruta" para la creación de patrones en las zanjas implica una secuencia de (al menos) dos exposiciones y grabados independientes de patrones independientes en la misma capa. Para cada exposición, se requiere un revestimiento de fotorresistencia diferente. Cuando se completa la secuencia, el patrón es un compuesto de los subpatrones grabados previamente. Al intercalar los subpatrones, la densidad del patrón se puede aumentar teóricamente de forma indefinida, siendo el semitono inversamente proporcional al número de subpatrones utilizados. Por ejemplo, se puede generar un patrón de semitono de 25 nm intercalando dos patrones de semitono de 50 nm, tres patrones de semitono de 75 nm o cuatro patrones de semitono de 100 nm. La reducción del tamaño de las características probablemente requerirá la ayuda de técnicas como encogimiento químico, reflujo térmico o películas de ayuda al encogimiento. Este patrón compuesto se puede transferir luego a la capa final.
Esto se describe mejor considerando un ejemplo de proceso. Una primera exposición de fotorresistencia se transfiere a una capa de máscara dura subyacente. Después de que se retira la fotorresistencia luego de la transferencia del patrón de máscara dura, se aplica una segunda capa de fotorresistencia sobre la muestra y esta capa se somete a una segunda exposición, lo que genera imágenes de características entre las características estampadas en la capa de máscara dura. El patrón de la superficie está formado por características de fotorresistencia bordeadas entre características de máscara, que se pueden transferir a la capa final que se encuentra debajo. Esto permite duplicar la densidad de características.
A veces, es necesario "unir" dos características impresas por separado en una sola característica. [47] [48] [49]
Una variación de este enfoque que elimina el primer grabado de máscara dura es la congelación de la resistencia [ 50] , que permite aplicar una segunda capa de resistencia sobre la primera capa de resistencia desarrollada. JSR ha demostrado líneas y espacios de 32 nm utilizando este método [51] , donde la congelación se logra mediante el endurecimiento de la superficie de la primera capa de resistencia.
En los últimos años, el alcance del término "división de paso" se ha ampliado gradualmente para incluir técnicas que involucran espaciadores de paredes laterales.

En el diseño de patrones con espaciadores , un espaciador es una capa de película formada en la pared lateral de una característica prediseñada. Un espaciador se forma por deposición o reacción de la película sobre el patrón anterior, seguida de un grabado para eliminar todo el material de la película en las superficies horizontales, dejando solo el material en las paredes laterales. Al eliminar la característica con patrón original, solo queda el espaciador. Sin embargo, dado que hay dos espaciadores para cada línea, la densidad de líneas ahora se ha duplicado. Esto se conoce comúnmente como diseño de patrones dobles autoalineados (SADP). La técnica del espaciador es aplicable para definir puertas estrechas a la mitad del paso litográfico original, por ejemplo.
Como la división de paso se ha vuelto más difícil debido a las posibles diferencias en las posiciones de las características entre las diferentes partes expuestas, la transferencia de imágenes de la pared lateral (SIT) se ha vuelto más reconocida como el enfoque necesario. El enfoque SIT generalmente requiere que se forme una capa espaciadora en la pared lateral de una característica grabada. Si este espaciador corresponde a una característica conductora, entonces en última instancia debe cortarse en no menos de dos ubicaciones para separar la característica en dos o más líneas conductoras como se espera típicamente. Por otro lado, si el espaciador corresponde a una característica dieléctrica, el corte no sería necesario. La predicción de cuántos cortes serían necesarios para patrones lógicos avanzados ha sido un gran desafío técnico. Se han publicado muchos enfoques para la creación de patrones espaciadores (algunos enumerados a continuación), todos ellos destinados a mejorar la gestión (y reducción) de los cortes.
Como los materiales espaciadores son comúnmente materiales de máscara dura , su calidad de patrón posterior al grabado tiende a ser superior en comparación con los perfiles de fotorresistencia después del grabado, que generalmente están plagados de rugosidad en los bordes de las líneas. [52]
Los principales problemas con el método de los espaciadores son si los espaciadores pueden permanecer en su lugar después de que se retire el material al que están adheridos, si el perfil del espaciador es aceptable y si el material subyacente es atacado por el grabado que elimina el material adherido al espaciador. La transferencia de patrones se complica por la situación en la que la eliminación del material adyacente a los espaciadores también elimina un poco del material subyacente. Esto da como resultado una topografía más alta en un lado del espaciador que en el otro. [53] Cualquier desalineación de las máscaras o excursión en la dimensión crítica (CD) de la característica pre-modelada hará que el paso entre las características se alterne, un fenómeno conocido como "caminata de paso". [54]
La posición del espaciador también depende del patrón al que está unido. Si el patrón es demasiado ancho o demasiado estrecho, la posición del espaciador se ve afectada. Sin embargo, esto no sería un problema para los procesos de fabricación de características de memoria críticas que están autoalineados.
Cuando se repite el SADP, se logra una reducción adicional a la mitad del paso. Esto se conoce a menudo como patrón cuádruple autoalineado (SAQP). Como 76 nm es el paso mínimo esperado para una exposición de litografía de inmersión única , [55] ahora se puede acceder a un paso de 19 nm con SAQP.
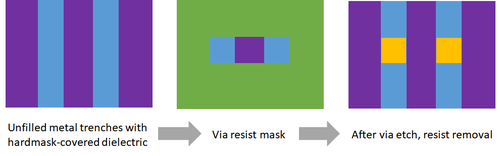
El patrón de contactos y vías autoalineados es un método establecido para crear patrones de contactos o vías múltiples a partir de una única característica litográfica. Utiliza la intersección de una máscara de resistencia de características ampliada y zanjas subyacentes que están rodeadas por una capa de máscara dura pre-modelada. Esta técnica se utiliza en celdas DRAM [56] y también se utiliza para lógica avanzada para evitar exposiciones múltiples de contactos y vías con división de paso. [57] [58] [59]
Desde el nodo de 32 nm, Intel ha aplicado el enfoque de vías autoalineadas mencionado anteriormente, que permite que dos vías separadas por un paso lo suficientemente pequeño (112,5 nm para el metal de 32 nm de Intel) [60] se diseñen con una abertura de resistencia en lugar de dos separadas. [59] Si las vías estuvieran separadas por menos del límite de resolución de paso de exposición única, se reduciría el número mínimo requerido de máscaras, ya que ahora se pueden reemplazar dos máscaras separadas para el par de vías originalmente separadas por una sola máscara para el mismo par.


En el patrón doble autoalineado (SADP), la cantidad de máscaras de corte/bloque se puede reducir o incluso eliminar en parches densos cuando el espaciador se usa para modelar directamente el dieléctrico intermetálico en lugar de las características metálicas. [61] La razón es que las ubicaciones de corte/bloque en las características del núcleo/mandril ya están modeladas en la primera máscara. Hay características secundarias que emergen de los espacios entre los espaciadores después de un patrón adicional. El borde entre una característica secundaria y el espaciador se autoalinea con la característica del núcleo vecina.
El uso de SID se puede aplicar a matrices 2D, agregando iterativamente características equidistantes de las características previamente presentes, duplicando la densidad con cada iteración. [62] [63] Se pueden realizar cortes que no requieran un posicionamiento ajustado en esta cuadrícula generada por espaciadores. [64]

Recientemente, Samsung demostró la creación de patrones de DRAM utilizando una estructura de panal (HCS) adecuada para 20 nm y más. [65] Cada iteración de creación de patrones de espaciadores triplica la densidad, lo que reduce efectivamente el paso 2D por un factor de sqrt(3). Esto es particularmente útil para DRAM ya que la capa de capacitores se puede adaptar a una estructura de panal, lo que hace que su creación de patrones sea más sencilla.

El SADP se puede aplicar dos veces seguidas para lograr un despiece efectivo. Esto también se conoce como patrón cuádruple autoalineado (SAQP). Con el SAQP, la dimensión crítica (CD) de la característica principal, así como el espaciado entre dichas características, se definen mediante el primer o el segundo espaciador.
Se prefiere que el segundo espaciador defina características no conductoras [66] para opciones de corte o recorte más flexibles.
SAQP tiene ventajas en el enrutamiento de paso de 28 nm bidimensional (seguido de dos pasos de corte/recorte de grabado selectivo), en comparación con EUV, debido a las limitaciones de iluminación de este último. [67]

La cantidad de máscaras utilizadas para la creación de patrones de espaciadores de paredes laterales se puede reducir con el uso de autoensamblaje dirigido (DSA) debido a la provisión de cortes en cuadrícula todos a la vez dentro de un área impresa, que luego se puede seleccionar con una exposición final. [68] [64] Alternativamente, el patrón de corte en sí mismo se puede generar como un paso de DSA. [69] Asimismo, un diseño de división por pasos se puede recombinar en pares. [70]
Se ha informado de un gran progreso en el uso de copolímeros de bloques de PMMA-PS para definir patrones de menos de 20 nm mediante autoensamblaje, guiado por la topografía de la superficie (grafoepitaxia) y/o el patrón químico de la superficie (quimioepitaxia). [71] El beneficio clave es el procesamiento relativamente simple, en comparación con múltiples exposiciones o múltiples deposiciones y grabados. El principal inconveniente de esta técnica es el rango relativamente limitado de tamaños de características y ciclos de trabajo para una formulación de proceso dada. Las aplicaciones típicas han sido líneas y espacios regulares, así como matrices de agujeros o cilindros muy juntos. [72] Sin embargo, también se pueden generar patrones aleatorios y aperiódicos utilizando patrones guía cuidadosamente definidos. [73]
La rugosidad del borde de la línea en los patrones de copolímeros en bloque depende en gran medida de la tensión de la interfaz entre las dos fases, que a su vez depende del parámetro "chi" de Flory (χ). [74] Se prefiere un valor más alto de χ para una rugosidad reducida; el ancho de interfaz entre dominios es igual a 2a(6χ) −1/2 , donde a es la longitud estadística de la cadena de polímero. [75] Además, se requiere χN > 10,5 para una segregación de fases suficiente, donde N es el grado de polimerización (número de repeticiones de monómero en la cadena). Por otro lado, el semipaso es igual a 2(3/π 2 ) 1/3 aN 2/3 χ 1/6 . Las fluctuaciones de los anchos de los patrones en realidad dependen solo débilmente (raíz cuadrada) del logaritmo del semipaso, por lo que se vuelven más significativas en relación con semipasos más pequeños.
El DSA aún no se ha implementado en la fabricación debido a preocupaciones por defectos, donde una característica no aparece como se esperaba en el autoensamblaje guiado. [76]
Ha habido numerosas preocupaciones de que la creación de patrones múltiples disminuye o incluso revierte la reducción de costos de nodo a nodo esperada con la Ley de Moore . La EUV es más cara que tres exposiciones 193i (es decir, LELELE), considerando el rendimiento. [77] Además, la EUV es más propensa a imprimir defectos de máscara más pequeños que no se pueden resolver con 193i. [78] A continuación se analizan algunos aspectos de otras técnicas de creación de patrones múltiples consideradas.

El patrón triple autoalineado se ha considerado como un sucesor prometedor del SADP, debido a su introducción de un segundo espaciador que ofrece flexibilidad adicional en el patrón 2D y mayor densidad. [79] [80] Un total de dos máscaras (mandril y recorte) son suficientes para este enfoque. [81] El único costo adicional en relación con el SADP es el de depositar y grabar el segundo espaciador. La principal desventaja de que el SATP suceda al SADP es que solo se podría usar para un nodo. Por esta razón, el patrón cuádruple autoalineado (SAQP) se considera con más frecuencia. Por otro lado, el flujo SADP SID convencional se puede extender de manera bastante natural al patrón triple, con la segunda máscara dividiendo el espacio en dos características. [82]

La implantación de iones inclinados fue propuesta en 2016 por la Universidad de Berkeley como un método alternativo para lograr el mismo resultado que el patrón de espaciadores. [83] En lugar de patrones de núcleo o mandril que soportan espaciadores depositados, un patrón de capa de enmascaramiento de iones protege una capa subyacente de ser dañada por la implantación de iones, lo que lleva a ser grabada en un proceso posterior. El proceso requiere el uso de haces de iones en ángulo que penetran hasta la profundidad adecuada, para no dañar las capas ya procesadas debajo. Además, la capa de enmascaramiento de iones debe comportarse idealmente, es decir, bloqueando el paso de todos los iones, mientras que también no se refleja en la pared lateral. El último fenómeno sería perjudicial y frustraría el propósito del enfoque de enmascaramiento de iones. Se han logrado zanjas tan pequeñas como 9 nm con este enfoque, utilizando la implantación de iones Ar+ de 15 keV en ángulos de 15 grados en una capa de enmascaramiento térmico de SiO2 de 10 nm . Un aspecto fundamental de este enfoque es la correlación entre el ancho del daño y el paso del daño; Ambos se ensanchan al mismo tiempo para una altura de máscara de iones fija y un ángulo de haz de iones.
El método de exposiciones complementarias [84] es otra forma de reducir las exposiciones de máscara para patrones múltiples. En lugar de múltiples exposiciones de máscara para vías, cortes o bloques individuales, se utilizan dos exposiciones de polaridad opuesta o complementaria, de modo que una exposición elimina las partes interiores del patrón de exposición anterior. Las regiones superpuestas de dos polígonos de polaridad opuesta no se imprimen, mientras que las regiones no superpuestas definen ubicaciones que se imprimen de acuerdo con la polaridad. Ninguna de las exposiciones modela las características objetivo directamente. Este enfoque también fue implementado por IMEC como dos máscaras de "mantenimiento" para la capa M0A en su celda SRAM de 7 nm. [85]

Actualmente, se está buscando el uso de bloqueo o corte autoalineado con SAQP para pasos de menos de 30 nm. [86] Las líneas que se van a cortar se dividen en dos materiales, que se pueden grabar de forma selectiva. Una máscara de corte solo corta cada dos líneas hechas de un material, mientras que la otra máscara de corte corta las líneas restantes hechas del otro material. Esta técnica tiene la ventaja de crear patrones de características de doble paso sobre líneas en el paso mínimo, sin errores de colocación de bordes. [37] Los diseños que favorecen el corte se procesan con el mismo número mínimo de máscaras (3), independientemente de que se utilice una longitud de onda DUV o EUV. [87]


Aunque se ha proyectado que la EUV será la litografía de elección de próxima generación , aún podría requerir más de una exposición litográfica, debido a la necesidad prevista de imprimir primero una serie de líneas y luego cortarlas; un solo patrón de exposición EUV tiene dificultades con el control del espaciado de extremo a extremo de la línea. [12] Además, la ubicación del extremo de la línea se ve afectada significativamente por el ruido de disparo de fotones.
Las herramientas EUV de NA 0,33 existentes se ven desafiadas por debajo de una resolución de medio paso de 16 nm. [88] Los espacios de punta a punta son problemáticos para dimensiones de 16 nm. [89] En consecuencia, la creación de patrones EUV 2D está limitada a un paso de >32 nm. [88] Estudios recientes de optimización simultánea de las características de la máscara EUV y la forma de la iluminación han indicado que diferentes patrones en la misma capa de metal podrían requerir diferentes iluminaciones. [90] [91] [92] [93] [94] Por otro lado, una única exposición solo ofrece una única iluminación.
Por ejemplo, en una optimización de máscara de fuente de paso cruzado para un nodo de 7 nm, para un paso de 40-48 nm y un paso de 32 nm, la calidad determinada por la pendiente logarítmica de la imagen normalizada fue insuficiente (NILS<2), mientras que solo el paso de 36 nm fue apenas satisfactorio para una exposición única bidireccional. [13]
La situación subyacente es que los patrones EUV pueden dividirse según diferentes iluminaciones para diferentes tonos o diferentes tipos de patrones (por ejemplo, matrices escalonadas frente a matrices regulares). [90] Esto podría aplicarse a patrones de corte de línea, así como a capas de contacto/vía. También es probable que se necesite más de un corte, incluso para EUV. [95]
En el taller EUVL de 2016, ASML informó que las herramientas EUV NXE con una NA de 0,33 no serían capaces de generar patrones de exposición única estándar para el paso medio de 11-13 nm esperado en el nodo de 5 nm. [96] Una NA más alta de 0,55 permitiría generar patrones EUV con exposición única de campos que son la mitad del tamaño de campo estándar de 26 mm x 33 mm. [96] Sin embargo, algunos productos, como Pascal Tesla P100 de NVIDIA, [97] se dividirán en dos por el tamaño de medio campo y, por lo tanto, requerirán la unión de dos exposiciones separadas. [98] En cualquier caso, dos escaneos de medio campo consumen el doble de sobrecarga de aceleración/desaceleración que un solo escaneo de campo completo. [96] [99]
Los defectos estocásticos, incluido el error de colocación de bordes, también implican una formación de patrones doble (o mayor) para contactos/vías con una distancia de centro a centro de 40 nm o menos. [100] [101]

Los patrones de memoria ya se modelan mediante patrones cuádruples para NAND [102] y patrones cuádruples/dobles cruzados para DRAM [103] . Estas técnicas de modelado se alinean automáticamente y no requieren máscaras de corte o recorte personalizadas. Para DRAM y flash de 2 nm, las técnicas de doble patrón deberían ser suficientes.
El rendimiento actual de la litografía EUV es aún más de tres veces más lento que el de la litografía de inmersión de 193 nm, lo que permite ampliar esta última mediante la creación de patrones múltiples. Además, la falta de una película EUV también es prohibitiva.
A partir de 2016, Intel estaba usando SADP para su nodo de 10 nm; [104] sin embargo, a partir de 2017, el paso de metal mínimo de 36 nm ahora se está logrando mediante SAQP. [105] Intel está usando patrones triples para algunas capas críticas en su nodo de 14 nm, [106] que es el enfoque LELELE. [107] El patrón triple ya se demostró en la cinta de 10 nm, [108] y ya es una parte integral del proceso de 10 nm de Samsung. [109] TSMC está implementando 7 nm en 2017 con patrones múltiples; [110] específicamente, división de tono, [111] hasta un paso de 40 nm. [112] Más allá del nodo de 5 nm, los patrones múltiples, incluso con asistencia EUV, serían económicamente desafiantes, ya que el abandono de la exposición única EUV aumentaría aún más el costo. Sin embargo, al menos hasta el medio paso de 12 nm, LELE seguido de SADP (SID) parece ser un enfoque prometedor, utilizando solo dos máscaras y también utilizando las técnicas de doble patrón más maduras, LELE y SADP. [113]

Ref.: A. Raley et al., Proc. SPIE 9782, 97820F (2016).
En comparación con el SADP 193i, el costo del SADP EUV está dominado por la exposición de la herramienta EUV, mientras que la diferencia de costo del SAQP 193i se debe a las deposiciones y grabados agregados. Se espera que el costo de procesamiento y la pérdida de rendimiento en una herramienta litográfica sean más altos en todo el flujo de proceso integrado debido a la necesidad de mover la oblea a ubicaciones específicas a alta velocidad. El EUV sufre además del límite de ruido de disparo, que obliga a que la dosis aumente en los nodos sucesivos. [114] Por otro lado, las deposiciones y grabados procesan obleas enteras a la vez, sin la necesidad de movimiento de la etapa de oblea en la cámara de proceso. De hecho, se pueden agregar múltiples capas debajo de la capa de resistencia para fines de antirreflejo o de máscara dura de grabado, solo para la exposición única convencional.

Incluso con la introducción de la tecnología EUV en algunos casos, se ha seguido implementando el patrón múltiple en la mayoría de las capas que se producen. Por ejemplo, Samsung sigue utilizando el patrón cuádruple para 7 nm. [120] El proceso de 7 nm+ de TSMC también utiliza EUV en un contexto de patrón múltiple. [123] De todos modos, solo unas pocas capas se ven afectadas; [124] muchas siguen utilizando el patrón múltiple convencional.
El costo de la máscara se beneficia considerablemente del uso de patrones múltiples. La máscara de exposición única EUV tiene características más pequeñas que tardan mucho más en escribirse que la máscara de inmersión. Aunque las características de la máscara son 4 veces más grandes que las características de la oblea, la cantidad de disparos aumenta exponencialmente para características mucho más pequeñas. Además, las características sub-100 nm en la máscara también son mucho más difíciles de modelar, con alturas de absorción de ≈70 nm. [125]
Nota: WPM = WPH * # herramientas * tiempo de actividad / # pases * 24 hrs/día * 30 días/mes. WPM normalizado = WPM/(WPM para EUV 1 pase)
Se puede esperar que la creación de patrones múltiples con escáneres de inmersión tenga una mayor productividad de obleas que la EUV, incluso con hasta 4 pasadas por capa, debido a un mayor rendimiento de exposición de obleas (WPH), una mayor cantidad de herramientas disponibles y un mayor tiempo de actividad.

La formación de patrones múltiples implica el uso de muchos pasos de procesamiento para formar una capa estampada, donde convencionalmente solo una exposición litográfica, una secuencia de deposición y una secuencia de grabado serían suficientes. En consecuencia, hay más fuentes de variaciones y posible pérdida de rendimiento en la formación de patrones múltiples. Cuando se involucra más de una exposición, por ejemplo, LELE o exposiciones de corte para SAQP, la alineación entre las exposiciones debe ser lo suficientemente ajustada. Las capacidades de superposición actuales son ≈0,6 nm para exposiciones de igual densidad (por ejemplo, LELE) y ≈2,0 nm para líneas densas frente a cortes/vías (por ejemplo, SADP o SAQP) en herramientas dedicadas o emparejadas. [127] Además, cada exposición debe cumplir con los objetivos de ancho especificados. Cuando se involucran espaciadores, el ancho del espaciador depende de la deposición inicial, así como de la duración del grabado posterior. Cuando se involucra más de un espaciador, cada espaciador puede introducir su propia variación de ancho. El error de superposición de la ubicación del corte también puede distorsionar los extremos de las líneas (lo que provoca arcos) o infringir una línea adyacente. [16] [17] [18]
La creación de patrones múltiples está evolucionando hacia una combinación de exposiciones múltiples, creación de patrones con espaciadores y/o EUV. En particular, dado que el escalado de punta a punta es difícil en una sola exposición con las herramientas EUV actuales, [12] puede ser necesario un enfoque de corte de línea. IMEC informó que la creación de patrones dobles se está convirtiendo en un requisito para EUV. [128]

Para la formación de patrones de línea, SADP/SAQP podría tener la ventaja sobre la exposición EUV, debido al costo y la madurez del primer enfoque y los problemas estocásticos de características faltantes o de puenteo del último. [134] Para la formación de patrones de ubicación de cuadrícula, una única exposición DUV después de la formación de la cuadrícula también tiene las ventajas de costo y madurez (por ejemplo, la litografía de inmersión puede no ser necesaria para la formación de patrones de espaciador en algunos casos) y no hay preocupaciones estocásticas asociadas con EUV. La selección de la ubicación de la cuadrícula tiene una ventaja sobre el corte de puntos directo porque este último es sensible a los errores de superposición y de ubicación de bordes estocásticos, que pueden distorsionar los extremos de la línea. [16] [17]
El litograbado-litograbado autoalineado (SALELE) es una técnica híbrida SADP/LELE cuya implementación ha comenzado en 7 nm [135] y continúa su uso en 5 nm. [136]
Desde 2017, varias publicaciones han indicado formas de mejorar la productividad de la creación de patrones múltiples. El bloqueo autoalineado permite que los patrones de bloqueo o corte crucen líneas adyacentes. [137] La redistribución de cortes permite ajustar las distancias entre cortes para minimizar la cantidad de máscaras de corte. [138] [139] Estas técnicas también se pueden combinar con vías autoalineadas, descritas anteriormente. [140]
La evolución de los patrones múltiples se está considerando en paralelo con el surgimiento de la litografía EUV. Si bien la litografía EUV satisface una resolución de 10 a 20 nm según consideraciones ópticas básicas, la aparición de defectos estocásticos [141], así como otras brechas de infraestructura y consideraciones de rendimiento, impiden su adopción en la actualidad. En consecuencia, los tapeouts de 7 nm se han realizado en gran medida sin EUV. [142] En otras palabras, los patrones múltiples no son prohibitivos, sino más bien una molestia y un gasto creciente.
El patrón cuádruple autoalineado (SAQP) ya es el proceso establecido que se utiliza para el patrón de aletas para FinFET de 7 nm y 5 nm . [143] Con SAQP, cada paso del patrón proporciona un valor de uniformidad de dimensión crítica (CDU) en el rango subnanómetro (3 sigma). Entre los fabricantes de lógica/fundición, solo Intel está aplicando SAQP a las capas de metal, a partir de 2017. [144]
El multipatrón agresivo con DUV solo se puede aplicar a 5 nm. [145]
El multipatrón agresivo con DUV se puede aplicar incluso a 3 nm. [146] Debido al mayor costo del multipatrón EUV, el multipatrón DUV ya no tiene una desventaja de costo. La reducción agresiva de máscara puede eliminar esencialmente la diferencia de número de máscara entre DUV y EUV para el patrón BEOL. [147]
Al igual que la memoria flash NAND, la memoria DRAM también ha hecho uso regular de patrones múltiples. Aunque las áreas activas forman una matriz bidimensional, una máscara de corte es suficiente para 20 nm. [148] Además, la máscara de corte se puede utilizar simultáneamente para crear patrones en la periferia y, por lo tanto, no se consideraría una máscara adicional. [149] Cuando el paso largo del área activa es ~3,5 x el paso corto, las roturas en el área activa forman una matriz hexagonal, que es susceptible al patrón de espaciador de red triangular mencionado anteriormente. Samsung ya ha comenzado a fabricar la memoria DRAM de 18 nm. [150] Se pueden utilizar exposiciones múltiples para el enrutamiento del metal de la periferia de la memoria DRAM, pero esto también es innecesario, ya que un enfoque de triple espaciador ofrece una reducción de paso de 1/5. [151]
La memoria flash NAND planar tenía varias capas que usaban SADP con un paso por debajo de los 80 nm y SAQP con un paso por debajo de los 40 nm.
La memoria flash NAND 3D utilizaba SADP para algunas capas. Si bien no escala tan agresivamente en sentido lateral, el uso del apilamiento de cadenas en NAND 3D implicaría el uso de patrones múltiples (estilo litograbado) para diseñar los canales verticales.
Por lo general, para NAND, SADP crea un conjunto de líneas a partir de una máscara de núcleo, seguido del uso de una máscara de recorte para eliminar los extremos de los bucles y la conexión de las almohadillas con una tercera máscara. [152]


No se descarta la posibilidad de crear patrones múltiples EUV, especialmente para el nodo de 5 nm. Esto se debe a varias razones. En primer lugar, está la especificación de ajuste de punta a punta (T2T), que representa la distancia mínima entre los extremos de las líneas metálicas. [153] Además, la distancia entre los cortes no debe ser demasiado pequeña como para exponer partes de las líneas intermedias.
Cuando el paso mínimo se reduce a 32 nm o menos, los defectos estocásticos son lo suficientemente frecuentes [154] como para reconsiderar el patrón doble en anchos de diseño mayores.
En pasos de ~30 nm o menos, la iluminación también se limita a rellenos de pupila extremadamente bajos por debajo del 20 %, [155] [156] lo que hace que una parte significativa de la potencia de la fuente EUV no se utilice, lo que reduce considerablemente el rendimiento.
Por lo tanto, la creación de patrones múltiples para EUV con reglas de diseño más amplias es actualmente una consideración práctica tanto por razones de rendimiento como de productividad.