Los tipos de defectos incluyen vacantes atómicas, adatomos , escalones y torceduras que ocurren con mayor frecuencia en las superficies debido al tamaño finito del material que causa la discontinuidad del cristal. Lo que todos los tipos de defectos tienen en común, ya sean defectos superficiales o en masa, es que producen enlaces colgantes que tienen niveles de energía electrónica específicos diferentes de los de la masa. Esta diferencia se produce porque estos estados no se pueden describir con ondas de Bloch periódicas debido al cambio en la energía potencial de los electrones causado por los núcleos iónicos faltantes justo fuera de la superficie. Por lo tanto, estos son estados localizados que requieren soluciones separadas a la ecuación de Schrödinger para que las energías de los electrones se puedan describir correctamente. La ruptura en la periodicidad da como resultado una disminución en la conductividad debido a la dispersión del defecto .

Una forma más simple y cualitativa de determinar los niveles de energía de los enlaces colgantes es con los diagramas de Harrison. [1] [2] Los metales tienen enlaces no direccionales y una pequeña longitud de Debye que, debido a su naturaleza cargada, hace que los enlaces colgantes sean intrascendentes si es que se puede considerar que existen. Los semiconductores son dieléctricos, por lo que los electrones pueden sentir y quedar atrapados en estados de energía defectuosos. Los niveles de energía de estos estados están determinados por los átomos que forman el sólido. La Figura 1 muestra el diagrama de Harrison para el semiconductor elemental Si. De izquierda a derecha, la hibridación de orbitales s y p promueve el enlace sp 3 que, cuando se combinan múltiples dímeros Si-Si sp 3 para formar un sólido, define las bandas de conducción y valencia. Si existiera una vacante, como las que hay en cada átomo en la interfaz sólido/vacío, se produciría al menos un enlace sp3 roto que tiene una energía igual a la de los átomos de Si autohibridados individuales, como se muestra en la Figura 1. Esta energía corresponde aproximadamente a la mitad de la banda prohibida del Si, ~0,55 eV por encima de la banda de valencia. Ciertamente, este es el caso más ideal, mientras que la situación sería diferente si se produjera, por ejemplo, la pasivación del enlace (ver a continuación) y la reconstrucción de la superficie . Experimentalmente, las energías de estos estados se pueden determinar utilizando espectroscopia de absorción o espectroscopia de fotoelectrones de rayos X , por ejemplo, si la sensibilidad del instrumento y/o la densidad de defectos son lo suficientemente altas.

Los semiconductores compuestos, como el GaAs, tienen estados de enlace colgantes que están más cerca de los bordes de la banda (ver Figura 2). A medida que el enlace se vuelve cada vez más iónico, estos estados pueden incluso actuar como dopantes . Esta es la causa de la conocida dificultad del dopaje de tipo p de GaN donde las vacantes N son abundantes debido a su alta presión de vapor que resulta en una alta densidad de enlace colgante de Ga. Estos estados están cerca del borde de la banda de conducción y, por lo tanto, actúan como donantes. Cuando se introducen dopantes aceptores de tipo p, son compensados inmediatamente por las vacantes N. Con estos estados superficiales, su tratamiento a menudo se considera como un análogo al átomo de hidrógeno de la siguiente manera para el caso de vacantes de aniones o cationes (masa efectiva del hueco, m*, para el catión y m* del electrón para las vacantes de aniones). La energía de enlace, E c -E db , es
donde U=-q 2 /(4πεε r r) es el potencial electrostático entre un electrón que ocupa el enlace colgante y su núcleo iónico con ε, la constante de permitividad del espacio libre, ε r , la permitividad relativa, y r la separación del núcleo electrón-ión. La simplificación de que la energía de traslación del electrón, KE=-U/2, se debe al teorema virial para potenciales centrosimétricos. Como se describe en el modelo de Bohr , r está sujeto a cuantificación .
El momento del electrón es p=mv=h/λ tal que
resulta en
y . Este tratamiento pierde precisión a medida que los defectos tienden a alejarse de cualquiera de los bordes de la banda.
Los niveles de energía de enlace colgante son valores propios de funciones de onda que describen electrones en la vecindad de los defectos. En la consideración típica de dispersión de portadores, esto corresponde al estado final en la regla de oro de Fermi de frecuencia de dispersión:
con H' siendo el parámetro de interacción y la función delta de Dirac , δ(E f -E i ), indicando dispersión elástica . La relación simple 1/τ= Σ k',k S k'k hace que esta sea una ecuación útil para caracterizar las propiedades de transporte de material cuando se usa junto con σ = ne 2 τ /m* y la regla de Matthiessen para incorporar otros procesos de dispersión.
El valor de S k'k está determinado principalmente por el parámetro de interacción, H'. Este término es diferente dependiendo de si se consideran estados superficiales o profundos. Para estados superficiales, H' es el término de perturbación del hamiltoniano redefinido H=H o +H', con H o teniendo una energía de valor propio de E i . La matriz para este caso es [3]
donde k' es el vector de onda del estado final del cual solo hay un valor ya que la densidad de defectos es lo suficientemente pequeña como para no formar bandas (~<10 10 /cm 2 ). Usando la ecuación de Poisson para cargas puntuales periódicas de Fourier, ,
da el coeficiente de Fourier del potencial de un enlace colgante V q =e/(q 2 εε r V) donde V es el volumen. Esto da como resultado
donde q s es la corrección del vector de onda de longitud de Debye debido al apantallamiento de carga. Entonces, la frecuencia de dispersión es donde n es la densidad de defectos volumétricos. Realizando la integración, utilizando |k|=|k'|, da .
El tratamiento anterior falla cuando los defectos no son periódicos, ya que los potenciales de enlace colgantes se representan con una serie de Fourier. La simplificación de la suma por el factor de n en la ecuación (10) solo fue posible debido a la baja densidad de defectos. Si cada átomo (o posiblemente cada uno de los demás) tuviera un enlace colgante, lo cual es bastante razonable para una superficie no reconstruida, también se debe realizar la integral en k'. Debido al uso de la teoría de perturbaciones para definir la matriz de interacción, lo anterior supone valores pequeños de H' o estados de defecto superficiales cerca de los bordes de la banda. Afortunadamente, la regla de oro de Fermi en sí es bastante general y se puede utilizar para defectos de estado profundo si la interacción entre el electrón de conducción y el defecto se entiende lo suficientemente bien como para modelar su interacción en un operador que reemplace a H'.

La determinación del grado de estos enlaces colgantes en el transporte eléctrico se puede observar experimentalmente con bastante facilidad. Al barrer el voltaje a través de un conductor (Figura 3), la resistencia y, con una geometría definida, se puede determinar la conductividad de la muestra. Como se mencionó anteriormente, σ = ne 2 τ /m*, donde τ se puede determinar conociendo n y m* a partir de la posición del nivel de Fermi y la estructura de la banda del material. Desafortunadamente, este valor contiene efectos de otros mecanismos de dispersión, como los debidos a los fonones. Esto gana utilidad cuando la medición se utiliza junto con la ecuación (11) donde la pendiente de un gráfico de 1/τ versus n hace que E c -E db sea calculable y la intersección determina 1/τ a partir de todos los procesos de dispersión excepto los de defectos. Esto requiere la suposición de que la dispersión de fonones (entre otros procesos posiblemente despreciables) es independiente de la concentración de defectos.
En un experimento similar, se puede simplemente reducir la temperatura del conductor (Figura 3) de modo que la densidad de fonones disminuya hasta ser insignificante, lo que permite que la resistividad sea dominante por defecto. En este caso, se puede utilizar σ = ne 2 τ /m* para calcular directamente τ para la dispersión de defectos.

Los defectos superficiales siempre se pueden "pasivar" con átomos para ocupar deliberadamente los niveles de energía correspondientes de modo que los electrones de conducción no puedan dispersarse en estos estados (disminuyendo efectivamente n en la ecuación (10)). Por ejemplo, la pasivación de Si en la interfaz canal/óxido de un MOSFET con hidrógeno (Figura 4) es un procedimiento típico para ayudar a reducir la densidad de defectos de ~10 10 cm −2 hasta en un factor de 12 [4] mejorando así la movilidad y, por lo tanto, las velocidades de conmutación. La eliminación de estados intermedios que de otro modo reducirían las barreras de tunelización también disminuye la corriente de fuga de la compuerta y aumenta la capacitancia de la compuerta , así como la respuesta transitoria. El efecto es que el enlace sp 3 de Si se satisface por completo. El requisito obvio aquí es la capacidad del semiconductor para oxidar el átomo pasivante o, E c -E db + χ > E I , con la afinidad electrónica del semiconductor χ y la energía de ionización del átomo E I .
Ahora consideramos la dispersión de portadores con deformaciones reticulares denominadas fonones . Consideremos el desplazamiento volumétrico que produce dicha onda que se propaga, , que en consecuencia da como resultado una deformación dependiente del tiempo, donde se utiliza una onda plana simple para describir la propagación de fonones, . El desplazamiento de los átomos lejos de sus posiciones de equilibrio generalmente causa un cambio en la estructura de la banda electrónica (Figura 5) donde, para la dispersión, nos ocupamos de los electrones en la banda de conducción con energía ~E CB , . El parámetro empírico, Z DP , se denomina potencial de deformación y describe la fuerza de acoplamiento electrón-fonón. Multiplicando por la población de fonones ( distribución de Bose-Einstein , N q ) se obtiene el potencial de deformación total,
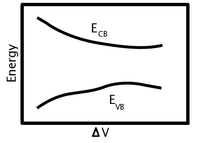
(la razón de la raíz se hará evidente a continuación). Aquí, el + corresponde a la emisión de fonones y el – a la absorción de fonones durante el evento de dispersión. Una nota, porque para los fonones transversales, solo las interacciones con fonones longitudinales son distintas de cero. Por lo tanto, la matriz de interacción completa es donde el delta de Kronecker impone la conservación del momento y surge de suponer que las funciones de onda electrónicas (estado final, , y estado inicial, ) también son ondas planas.
Usando la regla de oro de Fermi, la tasa de dispersión para fonones acústicos de baja energía puede ser aproximada. La matriz de interacción para estos fonones es con la frecuencia angular del fonón ω q = cq, volumen V, densidad sólida ρ, y velocidad del grupo de fonones c. [5] Reemplazando esto en la ecuación 6 se obtiene . Con los supuestos de que N q >>1, ħω<<kT y g(E') ~ g(E) (que generalmente se cumple para cristales 3D ya que las energías de los electrones de conducción son generalmente mucho mayores que ħω y g(E) carece de cualquier singularidad de van Hove ) se obtiene la tasa de dispersión: donde g(E) es la densidad electrónica de estados para los cuales se usó la solución tridimensional con dispersión parabólica para obtener la respuesta final.
Por lo general, los fonones en las ramas ópticas de las relaciones de dispersión vibracional tienen energías del orden de kT o mayores y, por lo tanto, no se pueden hacer las aproximaciones ħω<<kT y N q >>1. Sin embargo, una ruta razonable que aún proporciona un desvío de lidiar con dispersiones de fonones complejas es usar el modelo de Einstein que establece que solo existe un modo de fonón en sólidos. Para los fonones ópticos, esta aproximación resulta ser suficiente debido a muy poca variación de pendiente en ω(q) y, por lo tanto, podemos afirmar que ħω(q) ≅ ħω, una constante. En consecuencia, N q también es una constante (solo depende de T). La última aproximación, g(E')=g(E±ħω) ~ g(E), no se puede hacer ya que ħω ~ E y no hay solución alternativa para ella, pero la complejidad agregada a la suma para τ es mínima. .
La suma se convierte en la densidad de estados en E' y la distribución de Bose-Einstein se puede sacar de la suma debido a ħω(q) ≅ ħω.