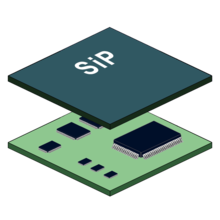
Un sistema en un paquete ( SiP ) o sistema en paquete es una serie de circuitos integrados (CI) encerrados en un paquete portador de chip o que abarca un sustrato de paquete de CI que puede incluir componentes pasivos y realizar las funciones de un sistema completo. Los circuitos integrados se pueden apilar usando paquete sobre paquete , colocarse uno al lado del otro y/o incrustarse en el sustrato. [1] El SiP realiza todas o la mayoría de las funciones de un sistema electrónico y normalmente se utiliza al diseñar componentes para teléfonos móviles , reproductores de música digital , etc. [2] Los troqueles que contienen circuitos integrados se pueden apilar verticalmente sobre el sustrato del paquete. Están conectados internamente mediante cables finos que están unidos al sustrato del paquete. Alternativamente, con una tecnología de chip invertido , se usan protuberancias de soldadura para unir chips apilados y al sustrato del paquete, o incluso se pueden usar ambas técnicas en un solo paquete. Los SiP son como sistemas en un chip (SoC), pero menos integrados y no en un solo chip semiconductor . [3]
Los SIP se pueden utilizar para reducir el tamaño de un sistema, mejorar el rendimiento o reducir costos. [4] [5] La tecnología evolucionó a partir de la tecnología de módulo de chip múltiple (MCM), con la diferencia de que los SiP también utilizan [[circuito integrado tridimensional |apilamiento de troqueles]], que apila varios chips o troqueles uno encima del otro. [6] [7]
Los troqueles SiP se pueden apilar verticalmente o en mosaico horizontalmente, con técnicas como chiplets o embalaje tipo quilt . Los SiP conectan los troqueles con uniones de cables fuera del chip estándar o protuberancias de soldadura, a diferencia de los circuitos integrados tridimensionales ligeramente más densos que conectan troqueles de silicio apilados con conductores que atraviesan el troquel mediante vías a través de silicio . Se han desarrollado muchas técnicas diferentes de empaquetado en 3D para apilar muchas matrices de chips bastante estándar en un área compacta. [8]
Los SiP pueden contener varios chips o matrices (como un procesador especializado , DRAM , memoria flash) combinados con componentes pasivos ( resistencias y condensadores ), todos montados en el mismo sustrato . Esto significa que se puede construir una unidad funcional completa en un solo paquete, de modo que es necesario agregar pocos componentes externos para que funcione. Esto es particularmente valioso en entornos con espacio limitado, como reproductores MP3 y teléfonos móviles, ya que reduce la complejidad de la placa de circuito impreso y el diseño general. A pesar de sus beneficios, esta técnica disminuye el rendimiento de la fabricación ya que cualquier chip defectuoso en el paquete dará como resultado un circuito integrado empaquetado no funcional, incluso si todos los demás módulos en ese mismo paquete son funcionales.
Los SiP contrastan con la arquitectura de circuito integrado del sistema común en un chip (SoC), que integra componentes basados en su función en un solo circuito . Un SoC normalmente integrará una CPU, interfaces de memoria y gráficos , conectividad de disco duro y USB , memorias de acceso aleatorio y de solo lectura , y almacenamiento secundario y/o sus controladores en un solo chip. En comparación, un SiP conectaría estos módulos como componentes discretos en uno o más paquetes de chips o matrices. Un SiP se asemeja a la arquitectura de PC tradicional común basada en una placa base , ya que separa los componentes según su función y los conecta a través de una placa de circuito de interfaz central. Un SiP tiene un menor grado de integración en comparación con un SoC. Los circuitos integrados híbridos son algo similares a los SiP, sin embargo, tienden a usar tecnología más antigua o menos avanzada (tienden a usar placas de circuito o sustratos de una sola capa, no usan apilamiento de troqueles, no usan chip invertido o BGA para conectar componentes o troqueles, usan solo unión de cables para matrices de conexión o paquetes de circuitos integrados de contorno pequeño, use paquetes duales en línea o paquetes simples en línea para interconectar fuera del IC híbrido en lugar de BGA, etc.). [9]
La tecnología SiP está siendo impulsada principalmente por las primeras tendencias del mercado en dispositivos portátiles , dispositivos móviles e Internet de las cosas que no exigen una gran cantidad de unidades producidas como en el mercado establecido de SoC para consumidores y empresas. A medida que Internet de las cosas se vuelve más una realidad y menos una visión, se están realizando innovaciones en el sistema a nivel de chip y SiP para que los sensores microelectromecánicos (MEMS) puedan integrarse en una matriz separada y controlar la conectividad. [10]
Las soluciones SiP pueden requerir múltiples tecnologías de empaquetado , como flip chip , unión de cables , empaquetado a nivel de oblea , vías a través de silicio (TSV), chiplets y más. [11] [12]