
La deposición química en fase de vapor ( CVD ) es un método de deposición al vacío que se utiliza para producir materiales sólidos de alta calidad y alto rendimiento. El proceso se utiliza a menudo en la industria de semiconductores para producir películas delgadas . [1]
En la CVD típica, la oblea (sustrato) se expone a uno o más precursores volátiles , que reaccionan y/o se descomponen en la superficie del sustrato para producir el depósito deseado. Con frecuencia, también se producen subproductos volátiles , que se eliminan mediante un flujo de gas a través de la cámara de reacción.
Los procesos de microfabricación utilizan ampliamente la CVD para depositar materiales en diversas formas, entre ellas: monocristalinos , policristalinos , amorfos y epitaxiales . Estos materiales incluyen: silicio ( dióxido , carburo , nitruro , oxinitruro ), carbono ( fibra , nanofibras , nanotubos , diamante y grafeno ), fluorocarbonos , filamentos , tungsteno , nitruro de titanio y varios dieléctricos de alto κ .
El término deposición química de vapor fue acuñado en 1960 por John M. Blocher, Jr. , quien pretendía diferenciar la deposición química de la deposición física de vapor (PVD).

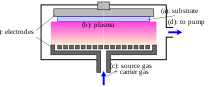
La CVD se practica en distintos formatos. Estos procesos generalmente difieren en los medios por los cuales se inician las reacciones químicas.
La mayoría de los métodos CVD modernos son LPCVD o UHVCVD.
La CVD se utiliza comúnmente para depositar películas conformadas y aumentar las superficies de los sustratos de maneras que las técnicas de modificación de superficies más tradicionales no son capaces de hacer. La CVD es extremadamente útil en el proceso de deposición de capas atómicas para depositar capas extremadamente delgadas de material. Existe una variedad de aplicaciones para tales películas. El arseniuro de galio se utiliza en algunos circuitos integrados (CI) y dispositivos fotovoltaicos. El polisilicio amorfo se utiliza en dispositivos fotovoltaicos. Ciertos carburos y nitruros confieren resistencia al desgaste. [9] La polimerización por CVD, quizás la más versátil de todas las aplicaciones, permite recubrimientos superdelgados que poseen algunas cualidades muy deseables, como lubricidad, hidrofobicidad y resistencia a la intemperie, por nombrar algunas. [10] Recientemente se ha demostrado la CVD de estructuras metalorgánicas , una clase de materiales nanoporosos cristalinos. [11] Recientemente ampliado como un proceso integrado de sala limpia que deposita sustratos de gran superficie, [12] se prevén aplicaciones para estas películas en la detección de gases y dieléctricos de bajo κ . Las técnicas de CVD también son ventajosas para los recubrimientos de membrana, como los de desalinización o tratamiento de agua, ya que estos recubrimientos pueden ser lo suficientemente uniformes (conformes) y delgados como para no obstruir los poros de la membrana. [13]
El silicio policristalino se deposita a partir de triclorosilano (SiHCl 3 ) o silano (SiH 4 ), mediante las siguientes reacciones: [14]
Esta reacción se lleva a cabo generalmente en sistemas LPCVD, ya sea con una materia prima de silano puro o con una solución de silano con un 70-80% de nitrógeno . Las temperaturas entre 600 y 650 °C y las presiones entre 25 y 150 Pa producen una tasa de crecimiento entre 10 y 20 nm por minuto. Un proceso alternativo utiliza una solución a base de hidrógeno . El hidrógeno reduce la tasa de crecimiento, pero la temperatura se eleva a 850 o incluso 1050 °C para compensar. El polisilicio se puede cultivar directamente con dopaje, si se añaden gases como fosfina , arsina o diborano a la cámara de CVD. El diborano aumenta la tasa de crecimiento, pero la arsina y la fosfina la disminuyen.
El dióxido de silicio (que en la industria de semiconductores suele llamarse simplemente " óxido") se puede depositar mediante varios procesos diferentes. Los gases fuente más comunes son el silano y el oxígeno , el diclorosilano (SiCl2H2 ) y el óxido nitroso [ 15] ( N2O ) o el tetraetilortosilicato (TEOS; Si(OC2H5 ) 4 ) . Las reacciones son las siguientes: [16]
La elección del gas fuente depende de la estabilidad térmica del sustrato; por ejemplo, el aluminio es sensible a las altas temperaturas. El silano se deposita entre 300 y 500 °C, el diclorosilano a alrededor de 900 °C y el TEOS entre 650 y 750 °C, lo que da como resultado una capa de óxido de baja temperatura (LTO). Sin embargo, el silano produce un óxido de menor calidad que los otros métodos (menor rigidez dieléctrica , por ejemplo) y se deposita de manera no conforme . Cualquiera de estas reacciones se puede utilizar en LPCVD, pero la reacción del silano también se realiza en APCVD. El óxido de CVD invariablemente tiene menor calidad que el óxido térmico , pero la oxidación térmica solo se puede utilizar en las primeras etapas de la fabricación de circuitos integrados.
El óxido también puede formarse con impurezas ( aleación o " dopaje "). Esto puede tener dos propósitos. Durante los pasos posteriores del proceso que ocurren a alta temperatura, las impurezas pueden difundirse desde el óxido a las capas adyacentes (principalmente silicio) y doparlas. Los óxidos que contienen entre un 5 y un 15 % de impurezas en masa se utilizan a menudo para este propósito. Además, el dióxido de silicio aleado con pentóxido de fósforo ("vidrio P") se puede utilizar para suavizar superficies irregulares. El vidrio P se ablanda y se refluye a temperaturas superiores a 1000 °C. Este proceso requiere una concentración de fósforo de al menos el 6 %, pero las concentraciones superiores al 8 % pueden corroer el aluminio. El fósforo se deposita a partir del gas fosfina y el oxígeno:
Los vidrios que contienen tanto boro como fósforo (vidrio de borofosfosilicato, BPSG) experimentan un flujo viscoso a temperaturas más bajas; se pueden alcanzar alrededor de 850 °C con vidrios que contienen alrededor del 5 % en peso de ambos componentes, pero la estabilidad en el aire puede ser difícil de lograr. El óxido de fósforo en altas concentraciones interactúa con la humedad ambiental para producir ácido fosfórico. Los cristales de BPO 4 también pueden precipitarse del vidrio que fluye al enfriarse; estos cristales no se graban fácilmente en los plasmas reactivos estándar utilizados para modelar óxidos y darán lugar a defectos en los circuitos integrados.
Además de estas impurezas intencionales, el óxido de CVD puede contener subproductos de la deposición. El TEOS produce un óxido relativamente puro, mientras que el silano introduce impurezas de hidrógeno y el diclorosilano introduce cloro .
También se ha estudiado la deposición a menor temperatura de dióxido de silicio y vidrios dopados a partir de TEOS utilizando ozono en lugar de oxígeno (350 a 500 °C). Los vidrios de ozono tienen una excelente conformabilidad pero tienden a ser higroscópicos, es decir, absorben agua del aire debido a la incorporación de silanol (Si-OH) en el vidrio. La espectroscopia infrarroja y la deformación mecánica en función de la temperatura son herramientas de diagnóstico valiosas para diagnosticar estos problemas.
El nitruro de silicio se utiliza a menudo como aislante y barrera química en la fabricación de circuitos integrados. Las dos reacciones siguientes depositan nitruro de silicio a partir de la fase gaseosa:
El nitruro de silicio depositado por LPCVD contiene hasta un 8 % de hidrógeno. También experimenta una fuerte tensión de tracción , que puede agrietar películas de más de 200 nm de espesor. Sin embargo, tiene una resistividad y una rigidez dieléctrica mayores que la mayoría de los aislantes comúnmente disponibles en microfabricación (10 16 Ω ·cm y 10 M V /cm, respectivamente).
Se pueden utilizar otras dos reacciones en el plasma para depositar SiNH:
Estas películas tienen mucha menos tensión de tracción, pero peores propiedades eléctricas (resistividad de 10 6 a 10 15 Ω·cm y rigidez dieléctrica de 1 a 5 MV/cm). [17]
La CVD de tungsteno, utilizada para formar contactos conductores, vías y tapones en un dispositivo semiconductor, [18] se logra a partir de hexafluoruro de tungsteno (WF 6 ), que puede depositarse de dos maneras:
Otros metales, en particular el aluminio y el cobre , pueden depositarse mediante CVD. En 2010 [actualizar], no existía una CVD comercialmente rentable para el cobre, aunque sí había fuentes volátiles, como Cu( hfac ) 2 . El cobre se deposita normalmente mediante galvanoplastia . El aluminio puede depositarse a partir de triisobutilaluminio (TIBAL) y compuestos organoaluminosos relacionados .
La CVD para molibdeno , tantalio , titanio y níquel se utiliza ampliamente. [19] Estos metales pueden formar siliciuros útiles cuando se depositan sobre silicio. Mo, Ta y Ti se depositan mediante LPCVD, a partir de sus pentacloruros. El níquel, el molibdeno y el tungsteno se pueden depositar a bajas temperaturas a partir de sus precursores carbonílicos. En general, para un metal arbitrario M , la reacción de deposición de cloruro es la siguiente:
Mientras que la reacción de descomposición del carbonilo puede ocurrir espontáneamente bajo tratamiento térmico o cavitación acústica y es la siguiente:
La descomposición de los carbonilos metálicos a menudo se precipita violentamente por la humedad o el aire, donde el oxígeno reacciona con el precursor del metal para formar metal u óxido de metal junto con dióxido de carbono.
Las capas de óxido de niobio (V) se pueden producir mediante la descomposición térmica del etóxido de niobio (V) con pérdida de éter dietílico [20] [21] según la ecuación:
Se pueden utilizar muchas variantes de CVD para sintetizar grafeno. Aunque se han logrado muchos avances, los procesos que se enumeran a continuación aún no son comercialmente viables.
La fuente de carbono más popular que se utiliza para producir grafeno es el gas metano. Una de las opciones menos populares es el asfalto de petróleo, que se destaca por ser económico pero más difícil de trabajar. [22]
Aunque el metano es la fuente de carbono más popular, se requiere hidrógeno durante el proceso de preparación para promover la deposición de carbono en el sustrato. Si la relación de flujo de metano e hidrógeno no es adecuada, provocará resultados indeseables. Durante el crecimiento del grafeno, la función del metano es proporcionar una fuente de carbono, la función del hidrógeno es proporcionar átomos de H para corroer el C amorfo, [23] y mejorar la calidad del grafeno. Pero los átomos de H excesivos también pueden corroer el grafeno. [24] Como resultado, se destruye la integridad de la red cristalina y se deteriora la calidad del grafeno. [25] Por lo tanto, al optimizar la velocidad de flujo de los gases de metano e hidrógeno en el proceso de crecimiento, se puede mejorar la calidad del grafeno.
El uso de catalizadores es viable para cambiar el proceso físico de producción de grafeno. Entre los ejemplos más destacados se incluyen las nanopartículas de hierro, la espuma de níquel y el vapor de galio. Estos catalizadores se pueden utilizar in situ durante la acumulación de grafeno [22] [26] o se pueden colocar a cierta distancia en el área de deposición [27] . Algunos catalizadores requieren otro paso para eliminarlos del material de muestra [26] .
El crecimiento directo de dominios monocristalinos de grafeno de gran tamaño y alta calidad sobre un sustrato dieléctrico es de vital importancia para aplicaciones en electrónica y optoelectrónica. Al combinar las ventajas tanto de la CVD catalítica como del sustrato dieléctrico ultraplano, la CVD asistida por catalizador gaseoso [28] allana el camino para sintetizar grafeno de alta calidad para aplicaciones en dispositivos, evitando al mismo tiempo el proceso de transferencia.
Las condiciones físicas como la presión circundante, la temperatura, el gas portador y el material de la cámara juegan un papel importante en la producción de grafeno.
La mayoría de los sistemas utilizan LPCVD con presiones que van desde 1 a 1500 Pa. [22] [27] Sin embargo, algunos todavía utilizan APCVD. [26] Las presiones bajas se utilizan más comúnmente ya que ayudan a prevenir reacciones no deseadas y producen un espesor de deposición más uniforme en el sustrato.
Por otra parte, las temperaturas utilizadas oscilan entre 800 y 1050 °C. [22] [26] Las temperaturas altas se traducen en un aumento de la velocidad de reacción. Se debe tener cuidado, ya que las temperaturas altas plantean niveles de peligro más elevados, además de mayores costos de energía.
Se introducen en el sistema gas hidrógeno y gases inertes como el argón. [22] [26] Estos gases actúan como portadores, mejorando la reacción de la superficie y la velocidad de reacción, aumentando así la deposición de grafeno sobre el sustrato.
En la deposición química de grafeno (CVD) se utilizan tubos y cámaras de cuarzo estándar. [29] [30] Se elige el cuarzo porque tiene un punto de fusión muy alto y es químicamente inerte. En otras palabras, el cuarzo no interfiere con ninguna reacción física o química independientemente de las condiciones.
La espectroscopia Raman, la espectroscopia de rayos X, la microscopía electrónica de transmisión (TEM) y la microscopía electrónica de barrido (SEM) se utilizan para examinar y caracterizar las muestras de grafeno. [29] [30]
La espectroscopia Raman se utiliza para caracterizar e identificar las partículas de grafeno; la espectroscopia de rayos X se utiliza para caracterizar los estados químicos; la TEM se utiliza para proporcionar detalles finos sobre la composición interna del grafeno; y la SEM se utiliza para examinar la superficie y la topografía.
A veces, se utiliza la microscopía de fuerza atómica (AFM) para medir propiedades locales como la fricción y el magnetismo. [29] [30]
La técnica de CVD de pared fría se puede utilizar para estudiar la ciencia de superficie subyacente involucrada en la nucleación y el crecimiento del grafeno, ya que permite un control sin precedentes de los parámetros del proceso, como los caudales de gas, la temperatura y la presión, como se demostró en un estudio reciente. El estudio se llevó a cabo en un sistema de pared fría vertical construido en casa que utiliza calentamiento resistivo al pasar corriente continua a través del sustrato. Proporcionó información concluyente sobre un mecanismo típico de nucleación y crecimiento mediado por la superficie involucrado en materiales bidimensionales cultivados mediante CVD catalítico en las condiciones buscadas en la industria de semiconductores. [31] [32]
A pesar de las interesantes propiedades electrónicas y térmicas del grafeno, no es adecuado como transistor para futuros dispositivos digitales debido a la ausencia de una banda prohibida entre las bandas de conducción y valencia. Esto hace que sea imposible cambiar entre los estados activado y desactivado con respecto al flujo de electrones. Si reducimos el tamaño, las nanocintas de grafeno de menos de 10 nm de ancho sí presentan bandas prohibidas electrónicas y, por lo tanto, son candidatas potenciales para dispositivos digitales. Sin embargo, el control preciso de sus dimensiones y, por lo tanto, de sus propiedades electrónicas representa un objetivo difícil, y las cintas suelen tener bordes ásperos que son perjudiciales para su rendimiento.


La CVD se puede utilizar para producir un diamante sintético creando las circunstancias necesarias para que los átomos de carbono en un gas se asienten en un sustrato en forma cristalina. La CVD de diamantes ha recibido mucha atención en las ciencias de los materiales porque permite muchas aplicaciones nuevas que anteriormente se habían considerado demasiado caras. El crecimiento de diamantes mediante CVD generalmente ocurre a baja presión (1–27 kPa ; 0,145–3,926 psi ; 7,5–203 Torr ) e implica introducir cantidades variables de gases en una cámara, energizándolos y proporcionando las condiciones para el crecimiento del diamante en el sustrato. Los gases siempre incluyen una fuente de carbono y, por lo general, también hidrógeno, aunque las cantidades utilizadas varían mucho según el tipo de diamante que se esté cultivando. Las fuentes de energía incluyen filamento caliente , energía de microondas y descargas de arco , entre otras. La fuente de energía está destinada a generar un plasma en el que se descomponen los gases y se producen químicas más complejas. El proceso químico real para el crecimiento de diamantes aún está en estudio y se complica por la gran variedad de procesos de crecimiento de diamantes utilizados.
Con la técnica de CVD, se pueden formar películas de diamante sobre grandes áreas de sustrato con control sobre las propiedades del diamante producido. En el pasado, cuando se utilizaban técnicas de alta presión y alta temperatura (HPHT) para producir un diamante, el resultado solía ser diamantes muy pequeños y de distintos tamaños. Con el diamante de CVD, se han logrado áreas de crecimiento de más de quince centímetros (seis pulgadas) de diámetro, y es probable que en el futuro se puedan recubrir con éxito áreas mucho más grandes con diamante. Mejorar este proceso es clave para permitir varias aplicaciones importantes.
El crecimiento del diamante directamente sobre un sustrato permite la incorporación de muchas de las cualidades importantes del diamante a otros materiales. Dado que el diamante tiene la conductividad térmica más alta de cualquier material a granel, la aplicación de capas de diamante sobre dispositivos electrónicos que producen mucho calor (como ópticas y transistores) permite que el diamante se utilice como disipador de calor. [33] [34] Se están cultivando películas de diamante en anillos de válvulas, herramientas de corte y otros objetos que se benefician de la dureza del diamante y su tasa de desgaste extremadamente baja. En cada caso, el crecimiento del diamante debe realizarse con cuidado para lograr la adhesión necesaria sobre el sustrato. La altísima resistencia al rayado y la conductividad térmica del diamante, combinadas con un coeficiente de expansión térmica más bajo que el vidrio Pyrex , un coeficiente de fricción cercano al del teflón ( politetrafluoroetileno ) y una fuerte lipofilia, lo convertirían en un revestimiento antiadherente casi ideal para utensilios de cocina si se pudieran recubrir grandes áreas de sustrato de forma económica.
El crecimiento por CVD permite controlar las propiedades del diamante producido. En el área del crecimiento de diamantes, la palabra "diamante" se utiliza para describir cualquier material compuesto principalmente de carbono con enlaces sp3 , y hay muchos tipos diferentes de diamantes incluidos en esto. Al regular los parámetros de procesamiento, especialmente los gases introducidos, pero también incluyendo la presión a la que se opera el sistema, la temperatura del diamante y el método de generación de plasma, se pueden fabricar muchos materiales diferentes que pueden considerarse diamantes. El diamante monocristalino se puede fabricar con varios dopantes . [35] Se puede cultivar diamante policristalino que consta de tamaños de grano de varios nanómetros a varios micrómetros . [33] [36] Algunos granos de diamante policristalino están rodeados de carbono delgado que no es diamante, mientras que otros no. Estos diferentes factores afectan la dureza, suavidad, conductividad, propiedades ópticas y más del diamante.
En el ámbito comercial, el telururo de mercurio y cadmio sigue siendo de interés para la detección de la radiación infrarroja. Este material, que consiste en una aleación de CdTe y HgTe, se puede preparar a partir de los derivados dimetílicos de los respectivos elementos.