
Un MOSFET de potencia es un tipo específico de transistor de efecto de campo de semiconductor de óxido metálico (MOSFET) diseñado para manejar niveles de potencia significativos. En comparación con otros dispositivos semiconductores de potencia , como un transistor bipolar de puerta aislada (IGBT) o un tiristor , sus principales ventajas son la alta velocidad de conmutación y la buena eficiencia a bajos voltajes. Comparte con el IGBT una puerta aislada que lo hace fácil de manejar. Pueden estar sujetos a baja ganancia, a veces hasta un grado en el que el voltaje de la puerta debe ser mayor que el voltaje bajo control.
El diseño de los MOSFET de potencia fue posible gracias a la evolución de la tecnología MOSFET y CMOS , utilizada para la fabricación de circuitos integrados desde la década de 1960. El MOSFET de potencia comparte su principio de funcionamiento con su homólogo de baja potencia, el MOSFET lateral. El MOSFET de potencia, que se utiliza habitualmente en electrónica de potencia , fue una adaptación del MOSFET estándar y se introdujo comercialmente en la década de 1970. [2]
El MOSFET de potencia es el dispositivo semiconductor de potencia más común en el mundo, debido a su baja potencia de accionamiento de compuerta, rápida velocidad de conmutación, [3] capacidad de paralelismo avanzado y fácil, [3] [4] amplio ancho de banda, robustez, fácil accionamiento, polarización simple, facilidad de aplicación y facilidad de reparación. [4] En particular, es el interruptor de bajo voltaje (menos de 200 V) más utilizado. Se puede encontrar en una amplia gama de aplicaciones, como la mayoría de las fuentes de alimentación , convertidores de CC a CC , controladores de motores de bajo voltaje y muchas otras aplicaciones.
El MOSFET fue inventado en Bell Labs entre 1955 y 1960. [5] [6] [7] [8] [9] [10] Fue un gran avance en la electrónica de potencia . Las generaciones de MOSFET permitieron a los diseñadores de potencia lograr niveles de rendimiento y densidad que no eran posibles con los transistores bipolares. [11]
En 1969, Hitachi introdujo el primer MOSFET de potencia vertical, [12] que más tarde se conocería como VMOS (MOSFET de ranura en V). [13] El mismo año, Y. Tarui, Y. Hayashi y Toshihiro Sekigawa del Laboratorio Electrotécnico (ETL) informaron por primera vez sobre el DMOS (MOSFET de doble difusión) con puerta autoalineada . [14] [15] En 1974, Jun-ichi Nishizawa en la Universidad de Tohoku inventó un MOSFET de potencia para audio, que pronto fue fabricado por Yamaha Corporation para sus amplificadores de audio de alta fidelidad . JVC , Pioneer Corporation , Sony y Toshiba también comenzaron a fabricar amplificadores con MOSFET de potencia en 1974. [16] Siliconix introdujo comercialmente un VMOS en 1975. [13]
Los VMOS y DMOS evolucionaron hasta convertirse en lo que se conoce como VDMOS (DMOS vertical). [16] El equipo de investigación de John Moll en HP Labs fabricó prototipos DMOS en 1977 y demostró ventajas sobre los VMOS, incluyendo una menor resistencia de encendido y un mayor voltaje de ruptura. [13] El mismo año, Hitachi introdujo el LDMOS (DMOS lateral), un tipo planar de DMOS. Hitachi fue el único fabricante de LDMOS entre 1977 y 1983, tiempo durante el cual los LDMOS se utilizaron en amplificadores de potencia de audio de fabricantes como HH Electronics (serie V) y Ashly Audio , y se utilizaron para sistemas de música y megafonía . [16] Con la introducción de la red móvil digital 2G en 1995, el LDMOS se convirtió en el amplificador de potencia de RF más utilizado en redes móviles como 2G, 3G , [17] y 4G . [18]
Alex Lidow co-inventó el HexFET, un tipo hexagonal de MOSFET de potencia, en la Universidad de Stanford en 1977, [19] junto con Tom Herman. [20] El HexFET fue comercializado por International Rectifier en 1978. [13] [20] El transistor bipolar de puerta aislada (IGBT), que combina elementos tanto del MOSFET de potencia como del transistor de unión bipolar (BJT), fue desarrollado por Jayant Baliga en General Electric entre 1977 y 1979. [21]
El MOSFET de superjunción es un tipo de MOSFET de potencia que utiliza columnas P+ que penetran la capa epitaxial N−. La idea de apilar capas P y N fue propuesta por primera vez por Shozo Shirota y Shigeo Kaneda en la Universidad de Osaka en 1978. [22] David J. Coe de Philips inventó el MOSFET de superjunción con capas de tipo p y tipo n alternadas mediante la presentación de una patente estadounidense en 1984 que fue otorgada en 1988. [23]


El MOSFET de potencia es el dispositivo semiconductor de potencia más utilizado en el mundo. [3] A partir de 2010 [actualizar], el MOSFET de potencia representa el 53% del mercado de transistores de potencia , por delante del transistor bipolar de puerta aislada (27%), el amplificador de potencia de RF (11%) y el transistor de unión bipolar (9%). [24] A partir de 2018 [actualizar], se envían anualmente más de 50 mil millones de MOSFET de potencia. [25] Estos incluyen el MOSFET de potencia de trinchera, que vendió más de 100 mil millones de unidades hasta febrero de 2017, [26] y el MDmesh (MOSFET de superunión) de STMicroelectronics , que ha vendido 5 mil millones de unidades a partir de 2019. [actualizar][ 22]
Los MOSFET de potencia se utilizan comúnmente para una amplia gama de productos electrónicos de consumo . [27] [28]
RF DMOS, también conocido como RF power MOSFET, es un tipo de transistor de potencia DMOS diseñado para aplicaciones de radiofrecuencia (RF). Se utiliza en diversas aplicaciones de radio y RF. [29] [30]
Los MOSFET de potencia se utilizan ampliamente en la tecnología de transporte , [31] [32] [33] que incluye una amplia gama de vehículos .
En la industria automotriz , [34] [35] [36] los MOSFET de potencia se utilizan ampliamente en la electrónica automotriz . [37] [38] [27]
Los MOSFET de potencia (incluidos DMOS, LDMOS y VMOS ) se utilizan comúnmente para una amplia gama de otras aplicaciones.

En la década de 1970, cuando se introdujeron los primeros MOSFET de potencia comerciales, se habían explorado varias estructuras. Sin embargo, la mayoría de ellas se han abandonado (al menos hasta hace poco) en favor de la estructura Vertical Diffused MOS ( VDMOS ) (también llamada Double-Diffused MOS o simplemente DMOS ) y la estructura LDMOS (laterally spreaded MOS).
La sección transversal de un VDMOS (ver figura 1) muestra la "verticalidad" del dispositivo: se puede ver que el electrodo fuente está colocado sobre el drenador, lo que da como resultado una corriente principalmente vertical cuando el transistor está en estado encendido. La " difusión " en VDMOS se refiere al proceso de fabricación: los pozos P (ver figura 1) se obtienen mediante un proceso de difusión (en realidad, un proceso de doble difusión para obtener las regiones P y N + , de ahí el nombre de doble difusión).
Los MOSFET de potencia tienen una estructura diferente a la de los MOSFET laterales: como ocurre con la mayoría de los dispositivos de potencia, su estructura es vertical y no plana. En una estructura plana, los valores nominales de corriente y voltaje de ruptura son funciones de las dimensiones del canal (respectivamente, ancho y largo del canal), lo que da como resultado un uso ineficiente del "espacio de silicio". Con una estructura vertical, el valor nominal de voltaje del transistor es una función del dopaje y el grosor de la capa epitaxial N (ver sección transversal), mientras que el valor nominal de corriente es una función del ancho del canal. Esto hace posible que el transistor mantenga tanto un alto voltaje de bloqueo como una alta corriente dentro de una pieza compacta de silicio.
Los LDMOS son MOSFET de potencia con una estructura lateral. Se utilizan principalmente en amplificadores de potencia de audio de alta gama , [16] y amplificadores de potencia de RF en redes celulares inalámbricas , como 2G , 3G , [17] y 4G . [18] Su ventaja es un mejor comportamiento en la región saturada (correspondiente a la región lineal de un transistor de unión bipolar) que los MOSFET verticales. Los MOSFET verticales están diseñados para aplicaciones de conmutación, por lo que solo se utilizan en estados encendido o apagado.

Cuando el MOSFET de potencia está en estado activado (consulte MOSFET para obtener información sobre los modos de funcionamiento), muestra un comportamiento resistivo entre los terminales de drenaje y fuente. En la figura 2 se puede ver que esta resistencia (denominada R DSon por "resistencia de drenaje a fuente en estado activado") es la suma de muchas contribuciones elementales:

Cuando está en estado OFF, el MOSFET de potencia es equivalente a un diodo PIN (constituido por la difusión P + , la capa epitaxial N− y el sustrato N + ) . Cuando esta estructura altamente no simétrica está polarizada en sentido inverso, la región de carga espacial se extiende principalmente en el lado dopado con luz, es decir , sobre la capa N− . Esto significa que esta capa tiene que soportar la mayor parte del voltaje de drenaje a fuente del MOSFET en estado OFF.
Sin embargo, cuando el MOSFET está en estado encendido, esta capa N − no tiene ninguna función. Además, como es una región ligeramente dopada, su resistividad intrínseca no es despreciable y se suma a la resistencia de drenaje a fuente (R DSon ) del estado encendido del MOSFET (esta es la resistencia R n en la figura 2).
Dos parámetros principales gobiernan tanto la tensión de ruptura como el R DSon del transistor: el nivel de dopaje y el espesor de la capa epitaxial N − . Cuanto más gruesa sea la capa y menor su nivel de dopaje, mayor será la tensión de ruptura. Por el contrario, cuanto más delgada sea la capa y mayor el nivel de dopaje, menor será el R DSon (y, por lo tanto, menores serán las pérdidas de conducción del MOSFET). Por lo tanto, se puede ver que existe un equilibrio en el diseño de un MOSFET, entre su voltaje nominal y su resistencia en estado encendido. [ cita requerida ] Esto se demuestra mediante el gráfico de la figura 3.
En la figura 1 se puede observar que la metalización de la fuente conecta tanto las implantaciones N + como P + , aunque el principio de funcionamiento del MOSFET solo requiere que la fuente esté conectada a la zona N + . Sin embargo, si así fuera, esto daría como resultado una zona P flotante entre la fuente y el drenador dopados con N, lo que es equivalente a un transistor NPN con una base no conectada. Bajo ciertas condiciones (bajo alta corriente de drenador, cuando el voltaje de drenador a fuente en estado encendido es del orden de algunos voltios), este transistor NPN parásito se dispararía, haciendo que el MOSFET sea incontrolable. La conexión de la implantación P a la metalización de la fuente cortocircuita la base del transistor parásito con su emisor (la fuente del MOSFET) y, por lo tanto, evita el enganche espurio. Esta solución, sin embargo, crea un diodo entre el drenador (cátodo) y la fuente (ánodo) del MOSFET, lo que lo hace capaz de bloquear la corriente en una sola dirección.
Los diodos de cuerpo se pueden utilizar como diodos de rueda libre para cargas inductivas en configuraciones como puente H o medio puente. Si bien estos diodos suelen tener una caída de tensión directa bastante alta, pueden manejar grandes corrientes y son suficientes en muchas aplicaciones, lo que reduce la cantidad de piezas y, por lo tanto, el costo del dispositivo y el espacio en la placa. Para aumentar la eficiencia, a menudo se utiliza la rectificación sincrónica para minimizar la cantidad de tiempo que el diodo de cuerpo conduce la corriente.

Debido a su naturaleza unipolar, el MOSFET de potencia puede conmutar a una velocidad muy alta. De hecho, no es necesario eliminar los portadores minoritarios como en el caso de los dispositivos bipolares. La única limitación intrínseca en la velocidad de conmutación se debe a las capacidades internas del MOSFET (ver figura 4). Estas capacidades deben cargarse o descargarse cuando el transistor conmuta. Este puede ser un proceso relativamente lento porque la corriente que fluye a través de las capacidades de compuerta está limitada por el circuito controlador externo. Este circuito dictará realmente la velocidad de conmutación del transistor (suponiendo que el circuito de potencia tenga una inductancia suficientemente baja).
En las hojas de datos de los MOSFET , las capacitancias se denominan a menudo C iss (capacidad de entrada, terminal de drenaje y fuente en cortocircuito), C oss (capacidad de salida, compuerta y fuente en cortocircuito) y C rss (capacidad de transferencia inversa, fuente conectada a tierra). La relación entre estas capacitancias y las que se describen a continuación es:
Donde C GS , C GD y C DS son respectivamente las capacitancias de compuerta a fuente, compuerta a drenaje y drenaje a fuente (ver a continuación). Los fabricantes prefieren citar C iss , C oss y C rss porque se pueden medir directamente en el transistor. Sin embargo, como C GS , C GD y C DS están más cerca del significado físico, se utilizarán en el resto de este artículo.
La capacitancia C GS está constituida por la conexión en paralelo de C oxN+ , C oxP y C oxm (ver figura 4). Como las regiones N + y P están altamente dopadas, las dos primeras capacitancias pueden considerarse constantes. C oxm es la capacitancia entre la compuerta (polisilicio) y el electrodo fuente (metal), por lo que también es constante. Por lo tanto, es una práctica común considerar C GS como una capacitancia constante, es decir, su valor no depende del estado del transistor.
La capacitancia C GD puede verse como la conexión en serie de dos capacitancias elementales. La primera es la capacitancia de óxido (C oxD ), constituida por el electrodo de compuerta, el dióxido de silicio y la parte superior de la capa epitaxial N. Tiene un valor constante. La segunda capacitancia (C GDj ) es causada por la extensión de la zona de carga espacial cuando el MOSFET está en estado apagado. Por lo tanto, depende del voltaje de drenaje a compuerta. A partir de esto, el valor de C GD es:
El ancho de la región de carga espacial está dado por [39]
donde es la permitividad del silicio, q es la carga del electrón y N es el nivel de dopaje . El valor de C GDj se puede aproximar utilizando la expresión del capacitor plano :
Donde A GD es el área de la superficie de superposición de la compuerta y el drenaje. Por lo tanto, se obtiene:
Se puede observar que C GDj (y por lo tanto C GD ) es una capacitancia cuyo valor depende de la tensión de compuerta a drenador. A medida que aumenta esta tensión, la capacitancia disminuye. Cuando el MOSFET está en estado encendido, C GDj se deriva, por lo que la capacitancia de compuerta a drenador permanece igual a C oxD , un valor constante.
Como la metalización de la fuente se superpone a los pozos P (ver figura 1), los terminales de drenaje y fuente están separados por una unión PN . Por lo tanto, C DS es la capacitancia de la unión. Esta es una capacitancia no lineal y su valor se puede calcular utilizando la misma ecuación que para C GDj .

Para que funcione, el MOSFET debe estar conectado al circuito externo, la mayoría de las veces mediante conexión por cable (aunque se están investigando técnicas alternativas). Estas conexiones presentan una inductancia parásita, que no es específica de la tecnología MOSFET, pero que tiene efectos importantes debido a las altas velocidades de conmutación. Las inductancias parásitas tienden a mantener su corriente constante y generan sobretensión durante el apagado del transistor, lo que resulta en un aumento de las pérdidas de conmutación.
A cada terminal del MOSFET se le puede asociar una inductancia parásita que tiene diferentes efectos:
El óxido de compuerta es muy fino (100 nm o menos), por lo que solo puede soportar un voltaje limitado. En las hojas de datos, los fabricantes suelen indicar un voltaje máximo de compuerta a fuente, alrededor de 20 V, y superar este límite puede provocar la destrucción del componente. Además, un voltaje alto de compuerta a fuente reduce significativamente la vida útil del MOSFET, con poca o ninguna ventaja en la reducción de R DSon .
Para solucionar este problema, a menudo se utiliza un circuito controlador de puerta .
Los MOSFET de potencia tienen un voltaje máximo especificado de drenaje a fuente (cuando están apagados), más allá del cual puede producirse una ruptura . Si se excede el voltaje de ruptura, el dispositivo conduce, lo que puede dañarlo a él y a otros elementos del circuito debido a la disipación excesiva de energía.
La corriente de drenaje debe permanecer generalmente por debajo de un valor especificado (corriente de drenaje continua máxima). Puede alcanzar valores más altos durante períodos de tiempo muy cortos (corriente de drenaje pulsada máxima, a veces especificada para varias duraciones de pulso). La corriente de drenaje está limitada por el calentamiento debido a pérdidas resistivas en componentes internos como cables de unión y otros fenómenos como la electromigración en la capa de metal.
La temperatura de unión (T J ) del MOSFET debe permanecer por debajo de un valor máximo especificado para que el dispositivo funcione de manera confiable, determinado por el diseño de la matriz del MOSFET y los materiales del encapsulado. El encapsulado a menudo limita la temperatura máxima de unión debido al compuesto de moldeo y las características del epoxi (cuando se utiliza).
La temperatura ambiente máxima de funcionamiento está determinada por la disipación de potencia y la resistencia térmica . La resistencia térmica de la unión a la carcasa es intrínseca al dispositivo y al encapsulado; la resistencia térmica de la carcasa al ambiente depende en gran medida de la disposición de la placa/montaje, el área de disipación de calor y el flujo de aire/fluido.
El tipo de disipación de potencia, ya sea continua o pulsada, afecta la temperatura máxima de funcionamiento , debido a las características de masa térmica ; en general, cuanto menor sea la frecuencia de los pulsos para una disipación de potencia dada, mayor será la temperatura ambiente máxima de funcionamiento, debido a que se permite un intervalo más largo para que el dispositivo se enfríe. Se pueden utilizar modelos, como una red Foster , para analizar la dinámica de temperatura a partir de transitorios de potencia.
El área de operación segura define los rangos combinados de corriente de drenaje y voltaje de drenaje a fuente que el MOSFET de potencia puede manejar sin sufrir daños. Se representa gráficamente como un área en el plano definido por estos dos parámetros. Tanto la corriente de drenaje como el voltaje de drenaje a fuente deben permanecer por debajo de sus respectivos valores máximos, pero su producto también debe permanecer por debajo de la disipación de potencia máxima que el dispositivo puede manejar. Por lo tanto, el dispositivo no puede funcionar con su corriente máxima y voltaje máximo simultáneamente. [40]
El circuito equivalente de un MOSFET de potencia consiste en un MOSFET en paralelo con un BJT parásito. Si el BJT se activa, no se puede desactivar, ya que la compuerta no tiene control sobre él. Este fenómeno se conoce como " latch-up ", que puede provocar la destrucción del dispositivo. El BJT se puede activar debido a una caída de tensión en la región del cuerpo de tipo p. Para evitar el latch-up, el cuerpo y la fuente suelen estar cortocircuitados dentro del encapsulado del dispositivo.


Como se describió anteriormente, la capacidad de manejo de corriente de un MOSFET de potencia está determinada por el ancho del canal de compuerta. El ancho del canal de compuerta es la tercera dimensión (eje Z) de las secciones transversales ilustradas.
Para minimizar el costo y el tamaño, es importante mantener el área de la matriz del transistor lo más pequeña posible. Por lo tanto, se han desarrollado optimizaciones para aumentar el ancho de la superficie del canal, es decir , aumentar la "densidad del canal". Estas optimizaciones consisten principalmente en crear estructuras celulares que se repiten en toda el área de la matriz del MOSFET. Se han propuesto varias formas para estas celdas, siendo la más famosa la forma hexagonal utilizada en los dispositivos HEXFET de International Rectifier.
Otra forma de aumentar la densidad de canales es reducir el tamaño de la estructura elemental. Esto permite que haya más celdas en una superficie determinada y, por lo tanto, más ancho de canal. Sin embargo, a medida que se reduce el tamaño de las celdas, se hace más difícil garantizar el contacto adecuado de cada celda. Para superar esto, a menudo se utiliza una estructura de "banda" (ver figura). Es menos eficiente que una estructura celular de resolución equivalente en términos de densidad de canales, pero puede hacer frente a un paso más pequeño. Otra ventaja de la estructura de banda plana es que es menos susceptible a fallas durante eventos de ruptura por avalancha en los que el transistor bipolar parásito se activa con una polarización directa suficiente. En la estructura celular, si el terminal de fuente de cualquier celda está mal contactado, entonces se vuelve mucho más probable que el transistor bipolar parásito se enganche durante un evento de ruptura por avalancha. Debido a esto, los MOSFET que utilizan una estructura de banda plana solo pueden fallar durante una ruptura por avalancha debido a un estrés térmico extremo. [41]
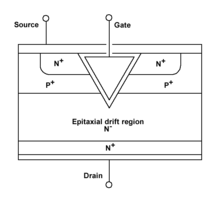

Un MOSFET de sustrato P (a menudo llamado PMOS) es un MOSFET con tipos de dopaje opuestos (N en lugar de P y P en lugar de N en la sección transversal de la figura 1). Este MOSFET está hecho utilizando un sustrato de tipo P, con una epitaxia P − . Como el canal se encuentra en una región N, este transistor se activa mediante una compuerta negativa a voltaje de fuente. Esto lo hace deseable en un convertidor reductor , donde uno de los terminales del interruptor está conectado al lado alto del voltaje de entrada: con un N-MOSFET, esta configuración requiere aplicar a la compuerta un voltaje igual a , mientras que no se requiere voltaje sobre con un P-MOSFET.
La principal desventaja de este tipo de MOSFET es el pobre rendimiento en estado encendido, ya que utiliza huecos como portadores de carga , que tienen una movilidad mucho menor que los electrones. Como la resistividad está directamente relacionada con la movilidad, un dispositivo PMOS determinado tendrá una movilidad tres veces mayor que un N-MOSFET con las mismas dimensiones.
La estructura VMOS tiene una ranura en V en la región de la compuerta y se utilizó para los primeros dispositivos comerciales. [42]
En esta estructura MOSFET de potencia, también llamada trinchera-MOS, el electrodo de compuerta está enterrado en una trinchera grabada en el silicio. Esto da como resultado un canal vertical. El principal interés de la estructura es la ausencia del efecto JFET. El nombre de la estructura proviene de la forma de U de la trinchera.
En particular, para tensiones superiores a 500 V, algunos fabricantes, entre ellos Infineon Technologies con sus productos CoolMOS, han comenzado a utilizar un principio de compensación de carga. Con esta tecnología, la resistencia de la capa epitaxial, que es la que más contribuye (más del 95 %) a la resistencia del dispositivo de los MOSFET de alta tensión, se puede reducir en un factor superior a 5.
Con el objetivo de mejorar la eficiencia y la fiabilidad de fabricación de los MOSFET de superunión, Renesas Electronics desarrolló una estructura de superunión con una técnica de proceso de zanja profunda. Esta tecnología implica el grabado de zanjas en el material de tipo N con baja impureza para formar regiones de tipo P. Este proceso supera los problemas inherentes al enfoque de crecimiento epitaxial de varios niveles y da como resultado una resistencia de encendido extremadamente baja y una capacitancia interna reducida.
Debido al aumento del área de unión pn, una estructura de superunión tiene un tiempo de recuperación inversa menor pero una corriente de recuperación inversa mayor en comparación con un MOSFET de potencia planar convencional.