
Los paquetes planos sin cables , como los cuádruples planos sin cables ( QFN ) y los dobles planos sin cables ( DFN ), conectan física y eléctricamente circuitos integrados a placas de circuito impreso . Flat sin cables, también conocido como micro leadframe (MLF) y SON (small-outline sin leads), es una tecnología de montaje en superficie , una de varias tecnologías de paquete que conectan circuitos integrados a las superficies de PCB sin orificios pasantes . Flat sin plomo es un paquete encapsulado de plástico casi a escala de chip fabricado con un sustrato de marco de plomo de cobre plano. Los terminales perimetrales en la parte inferior del paquete proporcionan conexiones eléctricas a la PCB . [1] Los paquetes planos sin plomo generalmente, pero no siempre, incluyen una almohadilla térmicamente conductora expuesta para mejorar la transferencia de calor fuera del IC (hacia la PCB). La transferencia de calor se puede facilitar aún más mediante vías metálicas en la almohadilla térmica. [2] El paquete QFN es similar al paquete cuádruple plano (QFP) y al conjunto de rejilla de bolas (BGA).
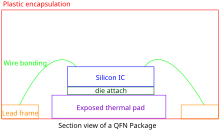
La figura muestra la sección transversal de un paquete plano sin plomo con un marco de plomo y conexión de cables . Hay dos tipos de diseños de cuerpo, singularización por punzón y singularización con sierra . [3] La singularización con sierra corta un gran conjunto de paquetes en partes. En la singularización por punzonado, se moldea un único paquete para darle forma. La sección transversal muestra un cuerpo aislado con una almohadilla térmica adjunta. El marco de plomo está hecho de aleación de cobre y se utiliza un adhesivo térmicamente conductor para fijar la matriz de silicona a la almohadilla térmica. La matriz de silicio está conectada eléctricamente al marco de cables mediante cables de oro de 1 a 2 mil de diámetro .
Las almohadillas de un paquete aislado con sierra pueden estar completamente debajo del paquete o pueden doblarse alrededor del borde del paquete.
Son comunes dos tipos de paquetes QFN: QFN con cavidad de aire , con una cavidad de aire diseñada en el paquete, y QFN moldeados en plástico con aire en el paquete minimizado.
Los QFN moldeados en plástico, menos costosos, suelen estar limitados a aplicaciones de hasta ~2–3 GHz. Por lo general, se compone de solo 2 partes, un compuesto de plástico y un marco de plomo de cobre, y no viene con tapa.
Por el contrario, el QFN de la cavidad de aire suele estar formado por tres partes; un marco de cobre, un cuerpo moldeado de plástico (abierto y no sellado) y una tapa de cerámica o plástico. Suele ser más caro debido a su construcción y puede utilizarse para aplicaciones de microondas de hasta 20 a 25 GHz.
Los paquetes QFN pueden tener una sola fila de contactos o una doble fila de contactos.
Este paquete ofrece una variedad de beneficios que incluyen una inductancia de plomo reducida, un tamaño pequeño "casi a escala de chip", un perfil delgado y un peso reducido. También utiliza paneles de E/S perimetrales para facilitar el enrutamiento de trazas de PCB, y la tecnología de panel de cobre expuesto ofrece un buen rendimiento térmico y eléctrico. Estas características hacen del QFN una opción ideal para muchas aplicaciones nuevas donde el tamaño, el peso y el rendimiento térmico y eléctrico son importantes.
Las tecnologías de embalaje mejoradas y la miniaturización de componentes a menudo pueden generar problemas de diseño, fabricación y confiabilidad nuevos o inesperados. Este ha sido el caso de los paquetes QFN, especialmente cuando se trata de su adopción por parte de nuevos fabricantes de equipos originales ( OEM) de productos electrónicos que no son de consumo .
Algunas consideraciones clave en el diseño de QFN son el diseño de almohadillas y plantillas. Cuando se trata del diseño de la almohadilla de unión, se pueden adoptar dos enfoques: máscara de soldadura definida (SMD) o máscara sin soldadura definida (NSMD). Un enfoque NSMD generalmente conduce a uniones más confiables, ya que la soldadura puede unirse tanto a la parte superior como a los lados de la almohadilla de cobre. [4] El proceso de grabado de cobre también generalmente tiene un control más estricto que el proceso de enmascaramiento de soldadura, lo que resulta en uniones más consistentes. [5] Esto tiene el potencial de afectar el rendimiento térmico y eléctrico de las juntas, por lo que puede ser útil consultar al fabricante del paquete para conocer los parámetros de rendimiento óptimos. Se pueden utilizar almohadillas SMD para reducir las posibilidades de que se produzcan puentes de soldadura ; sin embargo, esto puede afectar la confiabilidad general de las uniones. El diseño de la plantilla es otro parámetro clave en el proceso de diseño de QFN. El diseño de apertura y el grosor de la plantilla adecuados pueden ayudar a producir uniones más consistentes (es decir, mínimos huecos, desgasificación y piezas flotantes) con el grosor adecuado, lo que conduce a una mayor confiabilidad. [6]
También hay problemas en el lado de la fabricación. Para componentes QFN más grandes, la absorción de humedad durante el reflujo de soldadura puede ser una preocupación. Si el paquete absorbe una gran cantidad de humedad, el calentamiento durante el reflujo puede provocar una deformación excesiva del componente. Esto a menudo da como resultado que las esquinas del componente se levanten de la placa de circuito impreso , lo que provoca una formación inadecuada de las juntas. Para reducir el riesgo de problemas de deformación durante el reflujo, se recomienda un nivel de sensibilidad a la humedad de 3 o superior. [7] Varios otros problemas con la fabricación de QFN incluyen: parte flotante debido a un exceso de pasta de soldadura debajo de la almohadilla térmica central, grandes huecos de soldadura, características de reprocesamiento deficientes y optimización del perfil de reflujo de soldadura. [8]
El embalaje de componentes a menudo está impulsado por el mercado de la electrónica de consumo y se presta menos atención a industrias de mayor confiabilidad, como la automoción y la aviación. Por lo tanto, puede resultar complicado integrar familias de paquetes de componentes, como QFN, en entornos de alta confiabilidad. Se sabe que los componentes QFN son susceptibles a problemas de fatiga de soldadura , especialmente fatiga termomecánica debido al ciclo térmico . El enfrentamiento significativamente menor en los paquetes QFN puede provocar tensiones termomecánicas más altas debido a una discrepancia en el coeficiente de expansión térmica (CTE) en comparación con los paquetes con plomo. Por ejemplo, en condiciones de ciclos térmicos acelerados entre -40 °C y 125 °C, varios componentes de paquete plano cuádruple (QFP) pueden durar más de 10 000 ciclos térmicos, mientras que los componentes QFN tienden a fallar entre 1000 y 3000 ciclos. [7]
Históricamente, las pruebas de confiabilidad han sido impulsadas principalmente por JEDEC , [9] [10] [11] [12] sin embargo, esto se ha centrado principalmente en matrices e interconexiones de primer nivel. IPC -9071A [13] intentó solucionar este problema centrándose en las interconexiones de segundo nivel (es decir, el paquete al sustrato de PCB). El desafío con este estándar es que ha sido adoptado más por los OEM que por los fabricantes de componentes, quienes tienden a verlo como una cuestión específica de la aplicación. Como resultado, se han realizado muchas pruebas experimentales y análisis de elementos finitos en varias variantes de paquetes QFN para caracterizar su confiabilidad y comportamiento de fatiga de la soldadura . [14] [15] [16] [17] [18] [19] [20]
Serebreni et al. [21] propusieron un modelo semianalítico para evaluar la confiabilidad de las uniones de soldadura QFN bajo ciclo térmico. Este modelo genera propiedades mecánicas efectivas para el paquete QFN y calcula el esfuerzo cortante y la deformación utilizando un modelo propuesto por Chen y Nelson. [22] La densidad de energía de deformación disipada se determina a partir de estos valores y se utiliza para predecir los ciclos característicos hasta la falla utilizando una curva de Weibull de 2 parámetros .
El paquete QFN es similar al paquete plano cuádruple , pero los cables no se extienden desde los lados del paquete. Por lo tanto, es difícil soldar manualmente un paquete QFN, inspeccionar la calidad de la unión de soldadura o los cables de la sonda.
Diferentes fabricantes usan diferentes nombres para este paquete: ML (micro-leadframe) versus FN (plano sin plomo), además hay versiones con almohadillas en los cuatro lados (quad) y almohadillas en solo dos lados (dual), el grosor varía entre 0,9 y 1,0 mm para paquetes normales y 0,4 mm para paquetes extremadamente delgados. Las abreviaturas incluyen:

El paquete de marco de micro conductores (MLP) es una familia de paquetes QFN de circuitos integrados que se utilizan en diseños de circuitos electrónicos montados en superficie . Está disponible en 3 versiones que son MLPQ (Q significa quad ), MLPM (M significa micro ) y MLPD (D significa dual ). Estos paquetes generalmente tienen una almohadilla de fijación de matriz expuesta para mejorar el rendimiento térmico. Este paquete es similar a los paquetes de escala de chips (CSP) en la construcción. MLPD está diseñado para proporcionar un reemplazo compatible con el tamaño de los paquetes de circuitos integrados de contorno pequeño (SOIC).
El micro marco de plomo (MLF) es un paquete encapsulado de plástico casi CSP con un sustrato de marco de cobre. Este paquete utiliza zonas perimetrales en la parte inferior del paquete para proporcionar contacto eléctrico a la placa de circuito impreso . La paleta de fijación del troquel está expuesta en la parte inferior de la superficie del paquete para proporcionar una ruta de calor eficiente cuando se suelda directamente a la placa de circuito. Esto también permite una conexión a tierra estable mediante el uso de uniones descendentes o mediante una conexión eléctrica a través de un material conductor de fijación del troquel.
Una variación de diseño más reciente que permite conexiones de mayor densidad es el paquete de marco de micro cables de doble fila (DRMLF). Este es un paquete MLF con dos filas de conexiones para dispositivos que requieren hasta 164 E/S. Las aplicaciones típicas incluyen unidades de disco duro, controladores USB y LAN inalámbrica.
{{cite web}}: Mantenimiento CS1: copia archivada como título ( enlace )