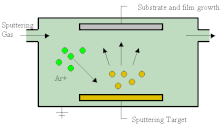
La deposición por pulverización catódica es un método de deposición física de vapor (PVD) de deposición de película delgada mediante el fenómeno de pulverización catódica . Esto implica expulsar material de un "objetivo" que es una fuente sobre un "sustrato" como una oblea de silicio . La repulsión catódica es la reemisión del material depositado durante el proceso de deposición mediante bombardeo de iones o átomos. [1] [2] Los átomos pulverizados expulsados del objetivo tienen una amplia distribución de energía, normalmente hasta decenas de eV (100.000 K ). Los iones pulverizados (normalmente solo una pequeña fracción de las partículas expulsadas están ionizadas , del orden del 1 por ciento) pueden volar balísticamente desde el objetivo en línea recta e impactar enérgicamente en los sustratos o la cámara de vacío (provocando la pulverización catódica). Alternativamente, a presiones de gas más altas, los iones chocan con los átomos de gas que actúan como moderador y se mueven de manera difusiva, alcanzando los sustratos o la pared de la cámara de vacío y condensándose después de sufrir un paseo aleatorio . Todo el rango desde el impacto balístico de alta energía hasta el movimiento termalizado de baja energía es accesible cambiando la presión del gas de fondo. El gas de pulverización catódica es a menudo un gas inerte como el argón . Para una transferencia de momento eficiente, el peso atómico del gas de pulverización catódica debe ser cercano al peso atómico del objetivo, por lo que para la pulverización catódica de elementos ligeros es preferible el neón , mientras que para los elementos pesados se utilizan el criptón o el xenón . [3] También se pueden utilizar gases reactivos para pulverizar compuestos. El compuesto se puede formar en la superficie del objetivo, en vuelo o en el sustrato según los parámetros del proceso. La disponibilidad de muchos parámetros que controlan la deposición catódica lo convierte en un proceso complejo, pero también permite a los expertos un gran grado de control sobre el crecimiento y la microestructura de la película.
Una de las primeras aplicaciones comerciales generalizadas de la deposición por pulverización catódica, que sigue siendo una de sus aplicaciones más importantes, es la producción de discos duros de ordenador . La pulverización catódica se utiliza ampliamente en la industria de los semiconductores para depositar películas delgadas de diversos materiales en el procesamiento de circuitos integrados . Los revestimientos antirreflejos delgados sobre vidrio para aplicaciones ópticas también se depositan mediante pulverización catódica. Debido a las bajas temperaturas del sustrato utilizadas, la pulverización catódica es un método ideal para depositar metales de contacto para transistores de película delgada . Otra aplicación familiar de la pulverización catódica son los revestimientos de baja emisividad sobre vidrio , utilizados en conjuntos de ventanas de doble panel. El revestimiento es una multicapa que contiene plata y óxidos metálicos como óxido de cinc , óxido de estaño o dióxido de titanio . Se ha desarrollado una gran industria en torno al revestimiento de brocas de herramientas utilizando nitruros pulverizados, como el nitruro de titanio , creando la conocida capa dura de color dorado. La pulverización catódica también se utiliza como proceso para depositar la capa de metal (por ejemplo, aluminio) durante la fabricación de CD y DVD.
Las superficies de los discos duros utilizan CrO x pulverizado y otros materiales pulverizados. La pulverización catódica es uno de los principales procesos de fabricación de guías de ondas ópticas y es otra forma de fabricar células solares fotovoltaicas y de película fina eficientes. [4] [5]
En 2022, los investigadores del IMEC construyeron qubits superconductores de laboratorio con tiempos de coherencia superiores a 100 μs y una fidelidad de compuerta de un solo qubit promedio del 99,94 %, utilizando técnicas de fabricación compatibles con CMOS, como deposición por pulverización catódica y grabado sustractivo. [6]

El recubrimiento por pulverización catódica en la microscopía electrónica de barrido es un proceso de deposición catódica [ aclaración necesaria ] para cubrir una muestra con una capa fina de material conductor, normalmente un metal, como una aleación de oro / paladio (Au/Pd). Se necesita un recubrimiento conductor para evitar que una muestra se cargue con un haz de electrones en el modo SEM convencional (alto vacío, alto voltaje). Si bien los recubrimientos metálicos también son útiles para aumentar la relación señal/ruido (los metales pesados son buenos emisores secundarios de electrones), son de calidad inferior cuando se emplea espectroscopia de rayos X. Por este motivo, cuando se utiliza espectroscopia de rayos X, se prefiere un recubrimiento de carbono. [7]

Una ventaja importante de la deposición por pulverización catódica es que incluso los materiales con puntos de fusión muy altos se pulverizan fácilmente, mientras que la evaporación de estos materiales en un evaporador de resistencia o una celda Knudsen es problemática o imposible. Las películas depositadas por pulverización catódica tienen una composición cercana a la del material de origen. La diferencia se debe a que los diferentes elementos se propagan de manera diferente debido a su diferente masa (los elementos ligeros se desvían más fácilmente por el gas), pero esta diferencia es constante. Las películas pulverizadas catódicamente suelen tener una mejor adhesión al sustrato que las películas evaporadas . Un objetivo contiene una gran cantidad de material y no requiere mantenimiento, lo que hace que la técnica sea adecuada para aplicaciones de ultra alto vacío. Las fuentes de pulverización catódica no contienen partes calientes (para evitar el calentamiento, normalmente se enfrían con agua) y son compatibles con gases reactivos como el oxígeno. La pulverización catódica se puede realizar de arriba hacia abajo, mientras que la evaporación debe realizarse de abajo hacia arriba. Son posibles procesos avanzados como el crecimiento epitaxial.
Algunas desventajas del proceso de pulverización catódica son que el proceso es más difícil de combinar con un despegue para estructurar la película. Esto se debe a que el transporte difuso, característico de la pulverización catódica, hace imposible una sombra completa. Por lo tanto, no se puede restringir por completo hacia dónde van los átomos, lo que puede provocar problemas de contaminación. Además, el control activo del crecimiento capa por capa es difícil en comparación con la deposición por láser pulsado y los gases de pulverización catódica inertes se incorporan a la película en crecimiento como impurezas. La deposición por láser pulsado es una variante de la técnica de deposición por pulverización catódica en la que se utiliza un haz láser para la pulverización catódica. El papel de los iones pulverizados y repulverizados y del gas de fondo se investiga a fondo durante el proceso de deposición por láser pulsado. [8] [9]

Las fuentes de pulverización catódica suelen emplear magnetrones que utilizan campos eléctricos y magnéticos fuertes para confinar partículas de plasma cargadas cerca de la superficie del objetivo de pulverización catódica. En un campo magnético, los electrones siguen trayectorias helicoidales alrededor de las líneas del campo magnético, experimentando más colisiones ionizantes con neutros gaseosos cerca de la superficie del objetivo de lo que ocurriría de otra manera. (A medida que el material del objetivo se agota, puede aparecer un perfil de erosión de "pista de carreras" en la superficie del objetivo). El gas de pulverización catódica es típicamente un gas inerte como el argón. Los iones de argón adicionales creados como resultado de estas colisiones conducen a una mayor tasa de deposición. El plasma también se puede mantener a una presión más baja de esta manera. Los átomos pulverizados tienen carga neutra y, por lo tanto, no se ven afectados por la trampa magnética. La acumulación de carga en los objetivos aislantes se puede evitar con el uso de pulverización catódica de RF donde el signo de la polarización del ánodo-cátodo se varía a una alta tasa (comúnmente 13,56 MHz ). [10] La pulverización catódica por radiofrecuencia funciona bien para producir películas de óxido altamente aislantes, pero con el gasto adicional de fuentes de alimentación de radiofrecuencia y redes de adaptación de impedancia . Los campos magnéticos dispersos que se filtran de los objetivos ferromagnéticos también alteran el proceso de pulverización catódica. A menudo se deben utilizar pistolas de pulverización catódica especialmente diseñadas con imanes permanentes inusualmente fuertes para compensar.

La pulverización catódica con haz de iones (IBS) es un método en el que el objetivo es externo a la fuente de iones . Una fuente puede funcionar sin ningún campo magnético como en un medidor de ionización de filamento caliente . En una fuente Kaufman, los iones se generan por colisiones con electrones que están confinados por un campo magnético como en un magnetrón. Luego son acelerados por el campo eléctrico que emana de una rejilla hacia un objetivo. A medida que los iones salen de la fuente, son neutralizados por electrones de un segundo filamento externo. La IBS tiene la ventaja de que la energía y el flujo de iones se pueden controlar de forma independiente. Dado que el flujo que golpea el objetivo está compuesto de átomos neutros, se pueden pulverizar objetivos aislantes o conductores. La IBS ha encontrado aplicación en la fabricación de cabezales de película delgada para unidades de disco . Se genera un gradiente de presión entre la fuente de iones y la cámara de muestra colocando la entrada de gas en la fuente y disparando a través de un tubo hacia la cámara de muestra. Esto ahorra gas y reduce la contaminación en aplicaciones de UHV . La principal desventaja del IBS es la gran cantidad de mantenimiento que requiere para mantener la fuente de iones en funcionamiento. [11]
En la pulverización catódica reactiva, las partículas pulverizadas de un material objetivo experimentan una reacción química con el objetivo de depositar una película con una composición diferente sobre un sustrato determinado. La reacción química que experimentan las partículas es con un gas reactivo introducido en la cámara de pulverización catódica, como oxígeno o nitrógeno, lo que permite la producción de películas de óxido y nitruro, respectivamente. [12] La introducción de un elemento adicional al proceso, es decir, el gas reactivo, tiene una influencia significativa en las deposiciones deseadas, lo que dificulta la búsqueda de puntos de trabajo ideales. Así, la gran mayoría de los procesos de pulverización catódica basados en reactivos se caracterizan por un comportamiento similar a la histéresis, por lo que necesitan un control adecuado de los parámetros involucrados, por ejemplo, la presión parcial de los gases de trabajo (o inertes) y reactivos, para socavarlo. [13] Berg et al. propusieron un modelo significativo, es decir, el modelo de Berg, para estimar el impacto de la adición del gas reactivo en los procesos de pulverización catódica. En general, la influencia de la presión relativa y el flujo del gas reactivo se estimaron de acuerdo con la erosión del objetivo y la tasa de deposición de la película sobre el sustrato deseado. [14] La composición de la película se puede controlar variando las presiones relativas de los gases inertes y reactivos. La estequiometría de la película es un parámetro importante para optimizar las propiedades funcionales como la tensión en SiN x y el índice de refracción de SiO x .
En la deposición asistida por iones (IAD), el sustrato se expone a un haz de iones secundario que funciona a una potencia menor que la del cañón de pulverización catódica. Normalmente, una fuente Kaufman, como la que se utiliza en IBS, suministra el haz secundario. La IAD se puede utilizar para depositar carbono en forma de diamante sobre un sustrato. Cualquier átomo de carbono que caiga sobre el sustrato y no se una correctamente en la red cristalina del diamante será expulsado por el haz secundario. La NASA utilizó esta técnica para experimentar con la deposición de películas de diamante sobre álabes de turbinas en la década de 1980. La IAD se utiliza en otras aplicaciones industriales importantes, como la creación de recubrimientos de superficie de carbono amorfo tetraédrico sobre platos de discos duros y recubrimientos de nitruro de metal de transición duro sobre implantes médicos.

La pulverización catódica también se puede realizar mediante la generación remota de un plasma de alta densidad. El plasma se genera en una cámara lateral que se abre hacia la cámara de proceso principal, que contiene el objetivo y el sustrato que se va a recubrir. Como el plasma se genera de forma remota, y no desde el propio objetivo (como en la pulverización catódica con magnetrón convencional ), la corriente de iones que llega al objetivo es independiente del voltaje aplicado al mismo.
HiPIMS es un método de deposición física de vapor de películas delgadas que se basa en la deposición por pulverización catódica con magnetrón. HiPIMS utiliza densidades de potencia extremadamente altas del orden de kW/cm2 en pulsos cortos (impulsos) de decenas de microsegundos con un ciclo de trabajo bajo de < 10%.
La pulverización catódica por flujo de gas hace uso del efecto de cátodo hueco , el mismo efecto por el que funcionan las lámparas de cátodo hueco . En la pulverización catódica por flujo de gas, un gas de trabajo como el argón se conduce a través de una abertura en un metal sometido a un potencial eléctrico negativo. [15] [16] Se producen densidades de plasma mejoradas en el cátodo hueco, si la presión en la cámara p y una dimensión característica L del cátodo hueco obedecen a la ley de Paschen 0,5 Pa·m < p · L < 5 Pa·m. Esto provoca un alto flujo de iones en las superficies circundantes y un gran efecto de pulverización catódica. Por lo tanto, la pulverización catódica por flujo de gas basada en cátodo hueco puede asociarse con grandes tasas de deposición de hasta valores de unos pocos μm/min. [17]
En 1974, JA Thornton aplicó el modelo de zona estructural para la descripción de morfologías de películas delgadas a la deposición por pulverización catódica. En un estudio sobre capas metálicas preparadas por pulverización catódica de corriente continua, [18] amplió el concepto de zona estructural introducido inicialmente por Movchan y Demchishin para películas evaporadas . [19] Thornton introdujo otra zona estructural T, que se observó a bajas presiones de argón y se caracterizó por granos fibrosos densamente empaquetados. El punto más importante de esta ampliación fue enfatizar la presión p como un parámetro decisivo del proceso. En particular, si se utilizan técnicas hipertérmicas como la pulverización catódica, etc. para la sublimación de átomos fuente, la presión gobierna a través del camino libre medio la distribución de energía con la que inciden en la superficie de la película en crecimiento. Junto a la temperatura de deposición T d, la presión de la cámara o el camino libre medio siempre deben especificarse al considerar un proceso de deposición.
Dado que la deposición catódica pertenece al grupo de procesos asistidos por plasma, junto a los átomos neutros también las especies cargadas (como los iones de argón) golpean la superficie de la película en crecimiento, y este componente puede ejercer un gran efecto. Denotando los flujos de los iones y átomos que llegan por J i y J a , resultó que la magnitud de la relación J i /J a juega un papel decisivo en la microestructura y morfología obtenida en la película. [20] El efecto del bombardeo de iones puede derivarse cuantitativamente de parámetros estructurales como la orientación preferida de los cristalitos o la textura y del estado de tensión residual . Se ha demostrado recientemente [21] que pueden surgir texturas y tensiones residuales en capas de Ti pulverizadas con flujo de gas que se comparan con las obtenidas en piezas de trabajo de Ti macroscópicas sometidas a una deformación plástica severa por granallado .